
碳化硅功率器件已成为一种很有前途的技术,人们对降低能耗和在高开关频率应用下运行的兴趣日益浓厚。碳化硅还可以维持较高的工作温度,使其成为工业环境的合适候选者。宽带隙半导体器件的可用性使工程师能够设计电力电子系统以满足特定的应用要求。与 SiC 一样,氮化镓也属于宽带隙类别。在设计任何电力系统之前要考虑的一些主要因素是成本、效率、功率密度、复杂性和可靠性。
由于开关速度快且导通电阻低,SiC MOSFET 通常容易因短路事件而损坏。3安徽工业大学电气与信息工程学院的一组研究人员展示了两种常用功率器件中 SiC 器件在短路事件中的失效模型:SiC MOSFET(来自 Cree 的 N 沟道增强型 SiC MOSFET ) 和 SiC JFET(通常在英飞凌的 SiC JFET 上)。
开发短路事件中 SiC 晶体管的故障模型
在 Wang 等人提出的一篇论文中,研究表明在短路事件下,故障电流高于功率器件的额定电流。5这意味着漏电流会导致故障电流,为了验证这一点,使用了技术计算机辅助设计 (TCAD) 模拟。SiC JFET 和 SiC MOSFET 的电流分量描述了两个 SiC 晶体管中的空穴电流密度。分析执行文件,我们可以得出结论,高密度空穴电流流过晶体管的 N 漂移区和 P 基区之间的 pn 结。“TCAD 仿真还表明,对于 SiC MOSFET,高浓度载流子聚集在 JFET 区域的顶部;其中一小部分注入到栅极氧化物中,在高温和高电场强度的应力下形成栅极漏电流,”该团队解释说。
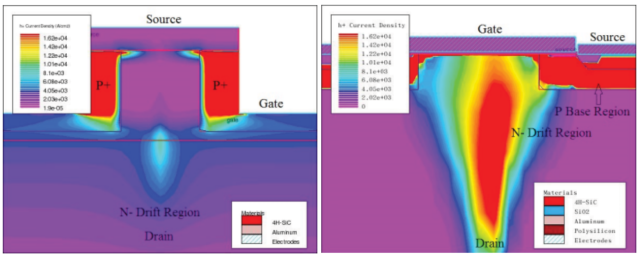
图 1:失效前 SiC JFET(左)和 SiC MOSFET(右)的空穴电流密度分布
考虑到漏电流的引入,设计了SiC JFET和 SiC MOSFET的故障模型示意图。虚线框中的结构是传统电路模型的一部分,与沟道电流 I CH并联的附加电流分量 I DS_LK是通过 N 漂移区和 P 基区之间的 pn 结的漏电流。晶体管。在这项研究中,研究人员明确指出,未考虑 SiC JFET 的栅极漏电流,因为栅极上没有电压偏置来开启器件。
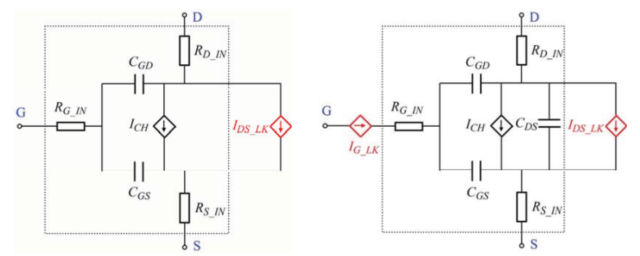
图 2:SiC JFET(左)和 SiC MOSFET(右)的故障模型
通过 pn 结的漏电流表达式由热产生电流 I th、雪崩电流 I av和扩散电流 I diff组成。然而,对于栅极氧化物中的漏电流,已经提出了几种方法,该团队已经考虑了 Fowler-Nordheim (FN) 隧穿和 Poole-Frenkel (PF) 发射。因此,电流 I FN和 I PF被认为对 SiC MOSFET 栅极氧化物的漏电流有贡献。
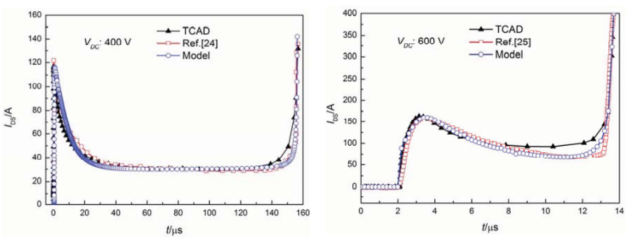
图 3:SiC JFET(左)和 SiC MOSFET(右)的故障模型验证
对于 SiC MOSFET 的电路仿真,使用基于 Shichman-Hodges 物理模型的 SPICE Level 1 模型来描述三种模式——截止区、线性区和饱和区——而对于 SiC JFET,Shockley 物理模型是用过的。通常,在短路事件中,沟道中的电荷载流子受到较高电流应力的影响,并被加热到相对于正常开关状态更高的温度。因此,沟道载流子的准确迁移率模型对于了解载流子行为对晶体管短路性能的影响非常重要。
验证失效模型
对 SiC JFET 和 SiC MOSFET 开发的故障模型的验证是在短路故障情况下完成的,图中显示了从模型中获得的故障电流与本文中给出的结果的比较。6,7结果表明,在 400 V 直流电压下,SiC JFET 的短路故障时间 (tSC) 为 150 μs,而 600 V 下的 SiC MOSFET 的短路故障时间 (tSC) 为 13 μs。(编者注:图 3 显示了参考文献 24 和 25,在本文中被视为参考文献 6 和 7。)
“取决于温度和电场强度的载流子迁移率对于准确开发 SiC 功率器件的故障模型是必要的,”该团队指出。“此外,通过改变 I DS_LK的三个电流分量的组合方式,可以得出结论 I TH决定了所开发的模型是否可以模拟设备的故障。因此,短路期间的发热电流决定了故障效应。”

图 4:比较短路事件性能的示意图
短路故障情况下的验证如图所示,V DC为直流母线电压,R S为电路回路的杂散电阻,R G为栅极电阻,DUT 为器件(SiC JFET或碳化硅 MOSFET)。图中展示了两种失效模式,红色曲线为第一种失效模式,蓝色曲线为第二种失效模式。注意到的一些参数是 SiC JFET 的失效时间比 SiC MOSFET 长得多,并且 SiC JFET 的饱和电流低于 SiC MOSFET。这些变化的原因是载流子迁移率的温度相关系数。

图 5:SiC JFET(左)和 SiC MOSFET(右)的两种故障模式
“对于立即失效,SiC JFET 表现出比 SiC MOSFET 更好的短路能力,并且 SiC JFET 的失效时间和临界失效能量都高于 SiC MOSFET,”该团队总结道。“对于延迟失效,在较低的直流母线电压下,SiC JFET 的失效时间远长于 SiC MOSFET;然而,对于更高的直流母线电压,两个 SiC 晶体管的故障时间差异似乎很小。”
审核编辑:汤梓红
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)