
随着半导体器件的质量和可靠性标准越来越高,高度集成、复杂的封装解决方案正在被采用,因此在失效分析中对解封提出了更高的要求。
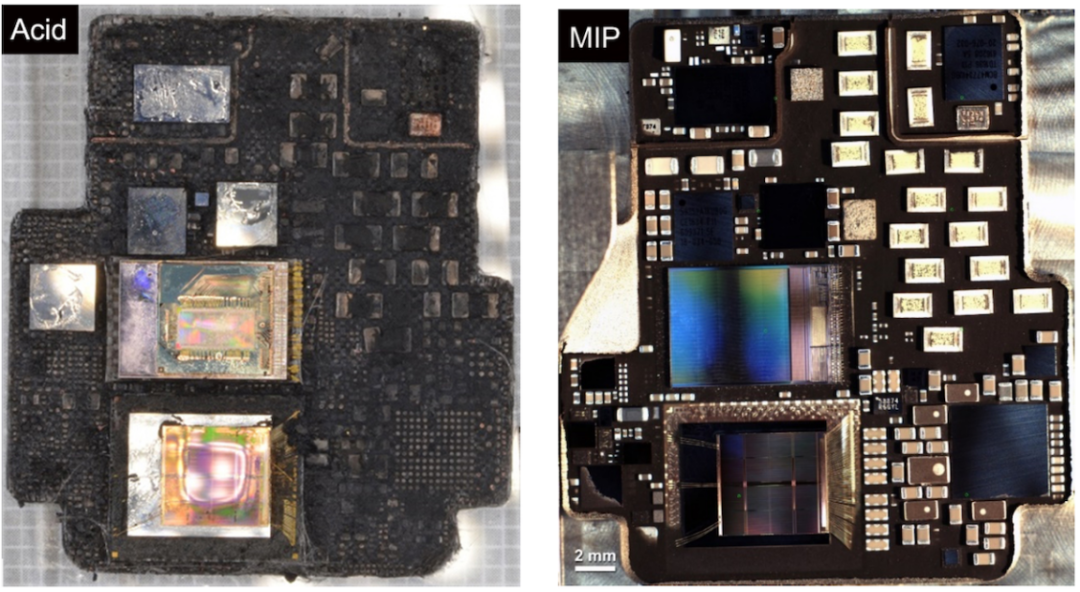
图1
2.5D封装是传统2D IC封装技术的进步,可实现更精细的线路与空间利用。在2.5D封装中,裸片堆叠或并排放置在具有硅通孔(TSV)的中介层顶部。其底座,即中介层,可提供芯片之间的互联。
3D晶圆级封装,包括CIS发射器、MEMS封装、标准器件封装。是指在不改变封装体尺寸的前提下,在同一个封装体内于垂直方向叠放两个以上芯片的封装技术,它起源于快闪存储器(NOR/NAND)及SDRAM的叠层封装。
随着半导体器件的质量和可靠性标准越来越高,必须采取广泛的措施来确保满足这些标准。与此同时,高度集成、复杂的封装解决方案(包括各种新材料和结构)正在被采用,以实现以前通过硅缩放所满足的经济和性能优势。这些因素要求使用高度先进的工具来分析潜在的故障,这通常需要物理访问芯片。在失效分析中获得明确的结果在很大程度上取决于样品制备的质量,例如选择性地去除封装材料,同时保留键合线,重新分布金属、焊盘、钝化、芯片和原始失效部位。
传统的解封方法
由于堆叠结构和相对较小的封装与芯片尺寸比,当使用涉及酸或基于四氟化碳(CF4)的反应离子蚀刻(RIE)系统的传统技术时,复杂的3D堆叠芯片封装的解封似乎非常具有挑战性。后两种技术具有固有的局限性,这在包含3D结构的高级软件包中尤为明显。
传统的酸解封装很容易由于过度暴露于酸而损坏顶层芯片和键合线,而中间和底层结构则保持未曝光。使用酸解封装时,保持封装周边以在特定测试插座中进行进一步的电气测试也非常具有挑战性。上面的功能照片比较了酸解封装(左)和MIP解封装后的26mmx29mm SiP模块。标有“酸”的图像表示系统级封装(SiP)模块的酸解封装引起的过度蚀刻和腐蚀损坏。
使用传统的基于CF4的反应离子蚀刻(RIE)解封装,使得到达中层和底层结构变得更加困难。此外,CF4经常对钝化层和硅晶片造成过度蚀刻损伤,因为这些材料很容易在氟等离子体中蚀刻。常用的RIE等离子系统中的高能离子轰击会损坏设备的电气功能,从而无法进行下一步的分析步骤。总而言之:使用基于酸或CF4的等离子体解封方法可能会引起原始结构的损坏或改变,并可能在根本原因失效分析期间引入腐蚀、过度蚀刻和外来污染,从而降低分析精度和置信水平。
微波诱导等离子体解封
为了克服传统解封技术的局限性并实现无伪影的样品制备,基于新型低功耗(P<100W)大气压微波诱导等离子体(MIP)开发了全自动解封机。MIP 工具的高度受限等离子束在等离子余辉中产生高通量的中性氧自由基,有助于实现金、银、铜和硅芯片等常见引线键合材料的高模塑料蚀刻速率和高蚀刻选择性。如前所述,常压纯氧MIP蚀刻可以实现模塑料对线材/焊盘/钝化/模具的高选择性。没有离子轰击和微波杂散场对于防止损坏封装内的器件至关重要。已经证明,半导体器件在使用MIP工具解封封装后仍保持完全功能。
MIP 工具由一个低功耗微波发生器 (2450 MHz)、一个定制的 Beenakker 型微波谐振腔、一个气体放电管、质量流量控制器、一个摄像头、一个可编程 XYZ 级、清洁单元和干燥单元组成(图 2)。
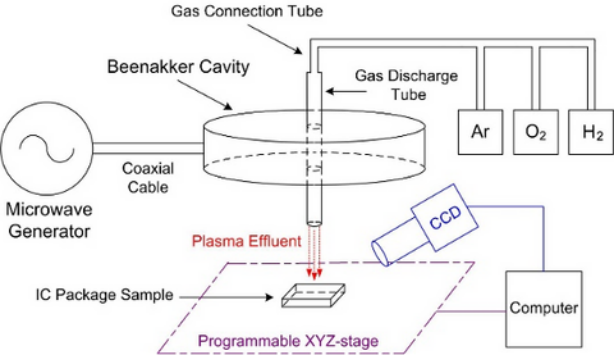
图 2.MIP系统的示意图
MIP 过程分两步执行。在第一步中,模塑料中的环氧树脂被MIP流出光束中的高密度氧自由基选择性地去除。在第二步中,在超声波去离子水浴中除去二氧化硅填充剂颗粒的剩余团聚层。重复这种蚀刻-清洁-干燥循环,从而能够逐层去除环氧树脂模塑料,同时保留中的功能组件和原始故障部位。
图3示出了所描述的MIP解封工艺流程。在MIP处理之前不一定需要样品制备。然而,为了优化工艺并减少整体解封时间,使用激光烧蚀或铣削方法去除顶丝环上方的散装模塑料是有帮助的。图3a显示了激光烧蚀后的封装,然后通过图3b中的MIP蚀刻,并在图3c中的去离子水中清洁以除去填充物颗粒。
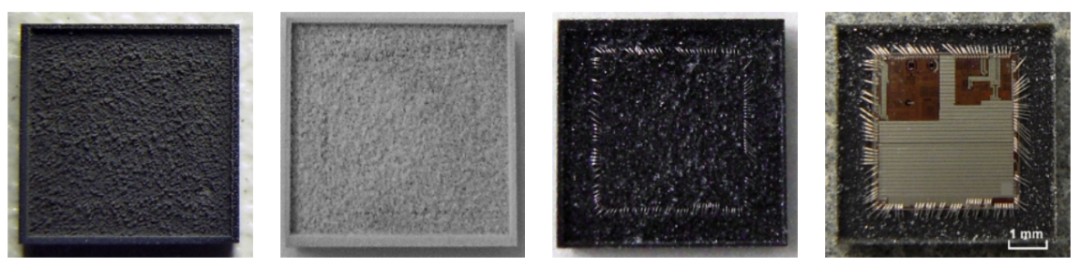
图 3.无卤MIP解封的工艺流程,显示a)激光烧蚀后的封装表面,b)随后进行MIP蚀刻,以及c)随后在去离子水中超声清洗以除去SiO2填料颗粒。d) 完全解封的样品。
MIP解封装工艺的蚀刻化学和随后的高选择性消除了过度延伸的风险,并有助于去除封装材料,同时确保键合线、键合焊盘、芯片、原始结构和失效部位保持在极好的状态。图1中标记为MIP的图像说明了使用MIP的SiP模块中所有有源和无源器件的无伪影曝光。图4显示了SiP模块上解封3D结构的更详细图像。

图 4.MIP解封装后SiP模块中第一层(a)和第二层闪存堆叠芯片(b)上的光学显微镜图像
使用 MIP 进行 2.5D 封装解封
作为MIP工具持续应用开发的一部分,最近将重点放在2.5D封装上,证明MIP工艺选择性地去除了2.5D封装上或两个模具之间的有机材料,例如环氧模塑料、底部填充物或聚酰亚胺,以实现进一步的分析步骤。2.5D 转接板芯片或 3D NAND 芯片上的铜微凸块、焊点、芯片焊盘曝光(自上而下或横截面曝光)是 MIP 与传统解封技术相比具有独特功能的领域。
例如,使用传统的解封装方法很难暴露转接板互连,因为层压板、芯片凸块和μ浮标会受到湿化学品的腐蚀。基于氟碳的等离子体蚀刻器将腐蚀钝化层,金属层和芯片硅。与此相反,大气压力MIP是一种高度选择性和各向同性的过程,可以暴露转接板互连,同时保留所有材料和原始故障点,从而允许进行后续的仔细分析。
使用大气压MIP工艺去除2.5D结构上方或周围的底部填充物不会改变样品上的所有其他材料。μBumps也可以从上到下或在横截面上干净地暴露出来(图5),从而能够分析进一步进入横截面的缺陷,同时保证样品制备不会引起伪影。

图 5.(a)MIP处理在横截面中暴露了第一排μpillars,(b)MIP工艺能够将第二行暴露到样品中,其中第一排μpillar被机械抛光成。
去除硅转接板上紧密间隔的芯片之间的封装材料是相当具有挑战性的。MIP 能够从这些非常高的纵横比空间中去除封装材料,从而可以在互连故障高风险区域检测硅转接板中的导电迹线。
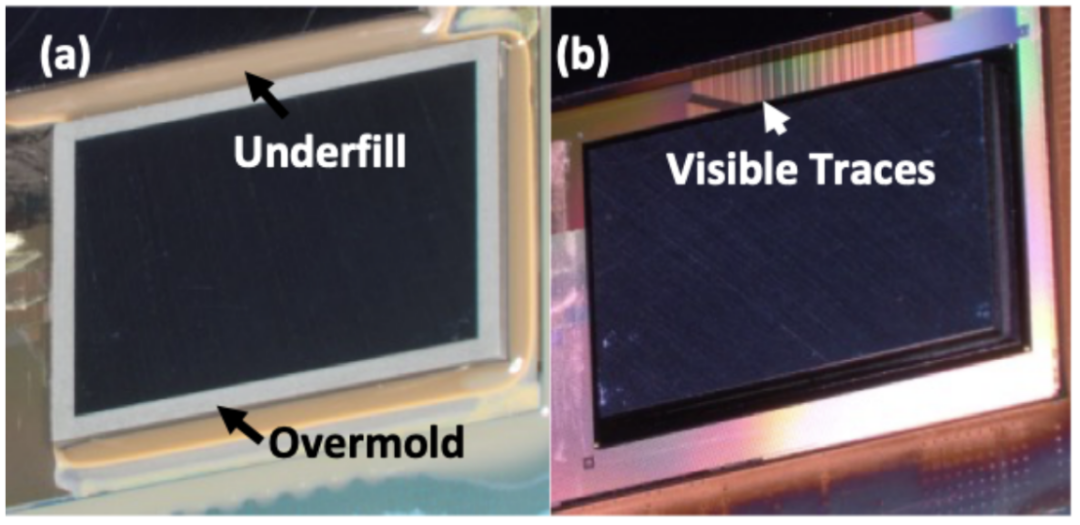
图 6.(a) 高带宽存储器 (HBM) 包覆成型和周围底部填充物的光学图像。(b) MIP处理后的HBM光学图像去除了转接板上和顶部芯片之间的包覆成型和底部填充。
大气压力MIP系统是无伪影解封的独特工具,可实现无可争议的故障识别。该系统的高蚀刻选择性、速度和可重复性可实现复杂的高级封装解封,确保相关故障分析和可靠性调查的高成功率。
编辑:黄飞
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)