
摘要:随着 GaN 功率放大器向小型化、大功率发展, 其热耗不断增加, 散热问题已成为制约功率器件性能提升的重要因素。金刚石热导率高达2 000 W/ (m·K), 是一种极具竞争力的新型散热材料, 可用作大功率器件的封装载片。采用不同载片材料对一款热耗为 53 W 的 GaN 功率放大器进行封装。分别采用有限元仿真及红外热成像仪对放大器的芯片结温进行仿真和测试,结果显示, 采用金刚石载片封装的放大器的结温比采用钼铜(MoCu30) 载片封装的放大器的结温降低了 30.01 ℃ , 约18. 69%。
同其他常用载片材料进行进一步对比得出, 在相同工作条件下,采用金刚石载片封装的放大器结温最低, 并且随着热耗增加, 金刚石的散热能力更为突出。在芯片安全工作温度 175 ℃以下, 金刚石能满足 GaN 功率放大器 100 W 热耗的散热需求。
0 引言
GaN 作为第三代半导体材料, 具有更高的自发极化系数及更大的压电系数, 能承受更高的功率密度,适用于高频、 高温大功率电子器件。但随着功率器件向小型化和大功率发展, 芯片有源区的热积累效应使 GaN 器件的大功率性能优势远未得到充分发挥。当器件温度上升时, 器件特性如漏源电流、 增益、输出功率和寿命等会出现退化, 甚至失效。研究表明,结温每升高 10 ~ 12 ℃ ,器件的寿命及可靠性会降低 50% , 散热问题已经成为限制 GaN 功率器件发展的主要瓶颈之一, 为解决此问题,提出了多种降低器件温度的散热方式,其中新型电子封装材料的研究开发成为解决 GaN功率器件散热问题的技术关键 。
金刚石的热导率高达 2000 W/ (m·K),是自然界中热导率仅次于石墨烯的材料,因此金刚石逐渐成为 GaN 器件封装材料的首选。近年来金刚石作为 GaN 器件的热沉材料和衬底材料,其技术和应用均取得较大进展。2005 年,W.Koh等人指出传统材料的热导率已无法满足高功率密度芯片的散热需求, 新型高热导率材料的开发和应用成为技术关 键。2012 年,M. J. Tadjer 等人提出在GaN 基 HEMT 器件上添加金刚石作为衬底材料,实验结果表明添加金刚石后有效降低了器件沟道温度,提高了器件饱和漏源电流。
2020 年,孙芮等人使用金刚石作为高功率半导体激光器的过渡热沉,并测试了激光器的输出特性,测试结果为金刚石作为热沉用于封装高功率器件提供了参考。但目前金刚石作为散热材料大多处于实验研究阶段,本文基于实际工程应用, 解决了金刚石表面不易被焊料浸润的问题,并对金刚石与其他材料的散热性能进行了对比,结果表明, 金刚石作为封装材料具有优异的散热性能。
1 功率放大器的封装结构及材料
本文研究对象是 Ku 波段 GaN 功率合成放大器, 该放大器用于卫星通信发射单元的末级功率输出,热耗较大。在连续波工作条件 下, 热耗为53 W。放大器的封装结构模型如图 1 所示, 模型主要包括两个 GaN 功率芯片、Au80Sn20 焊接层、载片、 印制电路板( PCB)、 In80Pb15Ag5 焊接层和盒体。
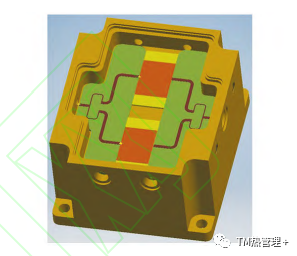
图 1 放大器封装结构模型
为了降低芯片的工作结温,基本理念是提高芯片有源区近端封装体的热导率,通过热传导的方式将热量迅速传输出去,避免热累积效应引起的局部温度升高。图 2 为传热模型示意图,可以看出,距离芯片最近的封装结构为载片,因此对超高热导率的载片材料的研制具有重要意义。
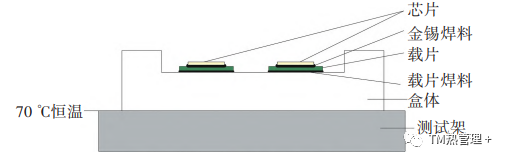
图 2 传热模型示意图
GaN 功率器件常用的载片材料有钨铜(WCu15 )、 钼铜 ( MoCu30 )、无氧铜 ( TU1 )、铜-钼铜-铜多层复合材料( Cu⁃MoCu⁃Cu, CPC)等,传统材料的热导率均较低,GaN 功率放大器最常用的载片材料为钼铜合金 (MoCu30),其热导率为 185 W/ (m·K)。
本实验采用高热导率的金刚石作为载片,金刚石载片由中国电子科技集团公司第十三研究所专用集成电路重点实验室提供,厚度为 0.3 mm,热导率为2000 W/ (m·K),表面粗糙度在 2nm 以内,达到国内领先水平,金刚石载片照片如图 3 所示。由于金刚石本身是绝缘材料,利用通孔电镀方式实现导通接地,同时解决了金刚石表面可焊性镀层的制备问题,金刚石载片与 Au80Sn20 焊料润湿性良好,空洞率控制在 5%以内。

图 3 金刚石载片照片
2 有限元仿真
2.1 热仿真模型及边界条件
在图 1 所示的封装结构中, GaN 功率芯片衬底为 SiC 材 料, 芯片尺寸为 5.0 mm × 6.65 mm ×0. 08 mm, 有源区面积为 4.28 mm2,芯片与载片通过 Au80Sn20 焊料连接;载片尺寸为 5. 0 mm ×10.6 mm×0.3 mm,载片与盒体通过 In80Pb15Ag5焊料连接。仿真模型中焊料层与实测器件保持一致,厚度为 0.05 mm,界面接触系数按照 5%空洞率设置。计算模型采用六面体进行网格划分,网格总数约为 30 万。模型中各部分材料参数如表 1 所示。
表 1 模型各部分材料参数

对特定产品进行有限元热仿真时,应根据相对应的使用条件选择合适的仿真方法。根据 GJB548B标准 1012 热性能测试方法进行芯片结温仿真。如图 3 所示,功率放大器安装于温度可控的测试架上, 测试架温度保持在 70 ℃ 。仿真按照恒温边界条件模拟散热器的冷却效果,其余外表面与空气进行自然对流, 总热耗为 53 W,分布于芯片的有源区,按照此设置进行连续波条件下的稳态热仿真分析。
2.2 仿真结果
通过热仿真得到两种载片材料封装的功率放大器温度场分布, 如图 4 所示。由图可以看出,采用MoCu30 载片的芯片结温为 159.17 ℃ ,采用金石载片的芯片结温为126. 91 ℃ ,金刚石载片较MoCu30 载片封装的放大器结温下降了 32.26 ℃ 。

图 4 采用不同载片的放大器的温度场分布仿真结果
3 测试验证
3.1 红外测试结果 为提高测量精度,利用同一台红外热成像仪对功率放大器结温直接进行测试,以减小测试误差。测试过程使用与有限元仿真中相同的工作条件,图5 为分别采用 MoCu30 载片和金刚石载片的两种放大器的表面温度分布热成像。由图可见, MoCu30和金刚石载片封装器件的芯片结温分别为160.60 ℃和 130.59 ℃ ,采用金刚石载片的芯片结温较 MoCu30 载片的降低了30.01 ℃ ,约 18.69%,与仿真结果趋势一致。

图 5 采用不同载片的放大器的热成像
3.2 仿真与测试结果对比
由于实际测试时,散热器通过导热硅脂与盒体相连, 不可能达到理想恒温条件,因此仿真散热效果要优于实际测试结果。将实测数据与仿真数据进行对比,可知仿真值与实测值误差在 3%之内,如表 2 所示。实测和仿真结果的一致性验证了采用金刚石载片的器件结温更低, 散热能力更好。 表 3 不同载片材料封装的芯片结温

4 金刚石与其他材料的散热性能对比
在实际生产之前进行热仿真, 能预先模拟出芯片的结温分布,对封装放大器进行温度评估预测。按照 2.1 节边界条件设置, 对芯片热耗为 53 W 的功率放大器进行热仿真。分别采用 5 种载片材料(WCu15、 MoCu30、CPC、TU1 和金刚石)进行热仿真,芯片结温的仿真结果如表 3 所示。从表中可看出相同热耗下 5 种载片材料的芯片结温对比情况。除金刚石以外,采用其他 4 种载片材料的芯片结温相近。其中, MoCu30 和 WCu15 的热导率相近,结温几乎没有差别,但 WCu15 密度高, X 射线不能穿透,烧结后无法进行空洞率检测, 因此MoCu30 是更好的选择;CPC 载片与 MoCu30 载片相对应的芯片结温相差不大,但CPC 加工工艺复杂、 成本高;TU1 载片对应的芯片结温比 MoCu30载片降低了约 12 ℃ ,但是 TU1 材质较软,易产生大形变,且与芯片的热膨胀系数相差较大;高热导率的金刚石载片相比 MoCu30 载片,芯片结温下降幅度超过 30 ℃ , 散热能力远远领先于其他所有材料。
为进一步验证金刚石载片的散热效果,对芯片热耗为 20~120 W 的功率放大器进行热仿真,得到不同载片材料相对应的芯片结温与热耗的关系,如图 6 所示。从图中可直观看出, 在 GaN 芯片的最高工作温度 175 ℃ 以下, WCu15、MCu30 材料仅能满足 60 W 左右热耗的散热,CPC 材料能满足65 W热耗的散热,TU1 材料能满足 70 W 热耗的散热,而金刚石可满足将近 100 W 热耗的散热需求。而且随功率放大器热耗的增加,金刚石与其他材料的结温差距越来越大,散热效果越来越显著。因此针对大功率器件,金刚石的散热优势尤为突出。

图 6 采用不同载片材料的芯片结温随热耗的变化曲线
5 结论
金刚石作为新一代电子封装材料,受到广泛重视,是最有潜力的封装材料之一。本文通过有限元仿真与红外测试相结合的方法,分析了采用常规载片材料 MoCu30 与新型载片材料金刚石载片封装的功率放大器结温。结果显示,金刚石载片封装的放大器结温降低了 30.01 ℃ ,约 18.69%。进一步利用有限元仿真对金刚石与其他 4 种材料在不同热耗条件下的散热效果进行了对比,结果表明金刚石散热效果最好, 可满足近 100 W 热耗的散热需求。基于降额考虑, 这对延长芯片使用寿命, 提高功率器件热可靠性具有重要意义。本文的研究成果为金刚石在大功率器件中的广泛应用提供了参考。
来源:《半导体技术》 封装、检测与设备
作者:崔朝探1,2 , 陈政1,2 , 郭建超3,4 , 赵晓雨1,2 , 何泽召3,4 , 杜鹏搏1,2,3,4 , 冯志红3,4 1. 河北新华北集成电路有限公司 2. 河北省卫星通信射频 技术创新中心 3. 中国电子科技集团公司 第十三研究所 4. 专用集成电路重点实验室 编辑:黄飞
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)