
毫米波长范围(30-300GHz)内除了其较低端外,还没有很好地被利用。而在成像,安全,医疗,和短距离无线传输以及数据速率不断提高的光纤传输中的新应用可能会迅速地改变这种状态[1],[2]。在过去的三十年里,III-V 技术(GaAs 和InP)已经逐渐扩大到这个毫米波范围中。新近以来,由于工艺尺寸持续不断地减小,硅技术已经加入了这个“游戏”。
在本文中,按照半导体特性和器件要求,对可用于100-GHz 和100-Gb/s 应用的半导体有源器件进行了综述。随后介绍了使用最广泛的技术,接着是两个不同方面具有竞争性的技术现状:分频器,来说明该技术适宜用在高速数字电路中,以及振荡器,用来说明其在模拟电路应用中的性能。
材料和工艺的基本特性
半导体材料的特性
运行在很高频率下的电子器件所表现的性能主要与:1)组成半导体的材料特性和2)器件的结构有关[3]。Si,GaAs 和InP 是目前具有截止频率在300GHz 及以上的器件所选择的材料。在表1,人们给出了一些相关的表征能隙,载流子输运特性和导热性的参数。同样也报道了与InP,GaN 和InAs 晶格相匹配的InGaAs 的特性。
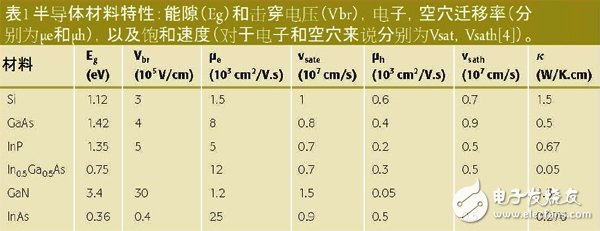
拥有一个足够大能隙(Eg>1eV )是很有利的,这是因为它可以提供好的击穿特性。Si,GaAs 和InP 在100nm 实际上可以承受几伏的电压水平;此外,p-n 结显示出很明晰的整流行为,室温下的泄漏电流可以忽略不计。采用GaN 可以获得更高的击穿电压,InAs 因为其能隙很低而只能用于电压很低的器件。
III-V 材料中的电子迁移率比硅的要大,这意味着在给定的掺杂浓度下,n-型接触区具有较低的串联电阻,而对于p-型 区来说,由于III-V 材料较低的空穴迁移率,情况则恰恰相反。然而,在器件的高场强区控制跨导和渡越时间的载流子速度与取决于载流子类型的饱和漂移速度相接近(Vsat 或Vsath′取决于载流子的类型;接近于10nm/ps)。由于暂态效应(电子从导带中的低能级,高迁移率能谷到达较高能级,较低迁移率能谷的转换不是瞬间发生的),电子的传输通常会受益于一些过冲量;例如,根据具有薄集电极的InP异质结双极性晶体管(HBT)的基极到集电极的渡越时间所推导出的有效速度大于3×107cm/s,大约是饱和速度的5 倍[5]。
甚高频率性能意味着较短的渡越时间和较低的RC寄生量;对于场效应管(FET)和双极性晶体管来说,这通常可以通过减小电子器件的尺寸和提高电流密度来实现(例如,见[6])。对于极高频器件和电路来说,热导率则成为一个重要的参数,硅在与其III-V 技术的对手相比时,其所具有的良好的导热性便成为一个真正的优势,因为这有可能达到更高的器件密度。
基于III-V 技术的早期单片微波集成电路(MMIC)的主要优点之一要归因于未掺杂(或补偿)基片的半绝缘特性,这是与其大的半导体能隙直接相关的(基片的电阻率为108Ω.cm 的数量级,而硅的电阻率为104Ω.cm)。这使得可以实现具有低关联寄生效应的电阻,电感和传输线。随着近来巨大的微波应用市场的开发(例如,移动电话网络),在硅基技术上引入无源器件这方面已经取得了很大的进展。此外,绝缘体加载硅基片技术(SOI)已经展示出其降低寄生效应的潜力(然而,这是以较低的基片导热率为代价的)。
服务于高频应用的FET 和双极性晶体管
今天,适用于高频应用的双极性晶体管和FET 是基于异质结结构的(除了是硅基MOSFET 以外)。对异质结的开发已经有40 多年了,并且在材料和晶格应力方面还在不断地发展着。两种不同材料(具有同样的晶体结构和同样的晶格参数)之间的异质结主要是由它们的能隙差异,以及由这种差异所区分的导带和价带的阶跃方式来表征的(表2)。在晶体管的有源区,异质结被用来达到两个不同的目的:

• 不论它们各自的掺杂浓度如何,保证双极性晶体管中从发射极向基极注入的是电子占主导地位的载流子
• 在高电子迁移率晶体管(HEMT)中将电子局限在未掺杂的量子肼中。
虽然最初是针对晶格匹配异质结来实施的,但很快就显示出用在失配异质结中也可以增强性能,条件是应力结晶层是在假晶厚度的极限内(如果生长层足够薄,其晶格常数会调整到基片的晶格常数)。这种特性被用在HBT 中(例如渐变组分的方法,graded-composiTIon)来生成具有短的渡越时间的基极层,以及高迁移率HEMT 的沟道层。在临界厚度以上,(失配程度越高,层厚就越薄),生长层松弛下来,在晶体结构中便会出现晶格脱位。这种现象仍然可以被用来在基片的顶部生成具有不同晶格参数的高质量晶体层,在中间有一个过渡层(缓冲层)来俘获大多数的脱位。例如,这种结构可以在被称为改性(metamorphic)HEMT 中找到,在松弛缓冲层之上又生长了一层高质量的活性异质结构。特别是,变性结构允许采用极高迁移率的InAs 沟道[7],[8]。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)