
引言
本文描述了我们华林科纳用于III族氮化物半导体的选择性侧壁外延的具有平面侧壁刻面的硅微米和纳米鳍的形成。通过湿法蚀刻取向的硅晶片生产鳍片。使用等离子体增强化学气相沉积来沉积二氧化硅,以产生硬掩模。二氧化硅通过分别用于微米和纳米鳍的光和电子束光刻形成图案,随后在氢氟酸中进行湿法蚀刻。使用用异丙醇(IPA)稀释的四甲基氢氧化铵(TMAH)以及具有表面活性剂(Triton-X-100)的硅掺杂TMAH/IPA溶液进行湿法蚀刻以产生硅鳍。使用原子力显微镜和扫描电子显微镜来确定形貌,包括鳍之间区域的表面粗糙度和硅的蚀刻速率。
介绍
硅蚀刻
在图案从光掩模转移到衬底之后,下一步是蚀刻衬底,以获得与抗蚀剂上完全相同的图案。硅蚀刻有两种分类标准。一种是基于蚀刻形状;另一种是基于蚀刻技术。蚀刻后的硅的形状可以是圆形的,也可以是尖角形的,分别称为各向同性蚀刻和各向同性蚀刻。对于IC制造,最常用的蚀刻技术包括湿法蚀刻、等离子体蚀刻和反应离子蚀刻,其中大多数可用于硅蚀刻。
2.1.各向异性蚀刻和各向同性蚀刻
各向同性蚀刻是一种非定向移除部分基板的蚀刻方法(图2.1 (a)),从而产生圆角。相反,各向异性蚀刻意味着每个晶体取向具有不同的蚀刻速率,因此拐角是尖锐的(图2.1 (b)、(c))。各向同性蚀刻的蚀刻角(图
2.1(a))是圆形的,并且每个平面的蚀刻速率相同。(100)取向硅的各向异性蚀刻形状是底角为54.74°的等腰形状(图2.1 (b))。对于各向异性蚀刻的(110)取向硅片(图2.1 (c)),总是形成U形槽。
2.1.1.硅的各向同性蚀刻
硅蚀刻最常用的各向同性蚀刻溶液是HNA,一种氢氟酸(HF)、硝酸(HNO3)和醋酸(CH3COOH)的混合物12].总体反应如下。
硅+硝酸+6HF h2sif 6+硝酸+ H2O + H2。
该反应是一个两步过程。首先,用硝酸氧化硅衬底。之后,HF溶液中的氟离子形成可溶性硅化合物H2SiF6。下一步是使用乙酸来防止硝酸分解。
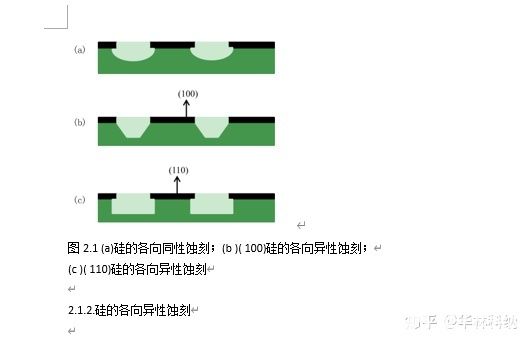
由于不同硅平面中的不同蚀刻速率,硅的各向异性蚀刻经常用于制造复杂形状,例如V形,U形槽,金字塔形凹坑,和金字塔形空腔.硅晶片的取向和掩模图案的形状决定了最终的蚀刻形状。大多数硅的各向异性蚀刻剂是碱性溶液,并且具有相同的总反应:
Si+2OH-+2H2O Si(OH)22-+2 H2。
硅的定向湿法蚀刻在微电子学中的应用得到了很好的发展。值得注意的蚀刻剂包括氢氧化钾(KOH)、乙二胺焦儿茶酚(EDP)和四甲基氢氧化铵(TMAH)。
首次发现EDP可用于硅各向异性腐蚀。在他们的实验中,三个主要取向和的蚀刻比是17∶10∶1。在所有无机碱性溶液中,KOH最常用于各向异性蚀刻。然而,由于EDP是致癌的,并且KOH在溶液中含有钾,这与ic生产不相容,TMAH由于其低污染和无毒而受欢迎。
.湿法腐蚀
湿法蚀刻是一种纯化学反应。它通常由三个步骤组成:蚀刻剂分子移动到晶片表面,表面和晶片之间发生化学反应,反应产物远离晶片。
二氧化硅湿法蚀刻是最常见的湿法蚀刻工艺,通过将二氧化硅浸泡在稀释的HF中一段时间。缓冲HF-改良是典型的蚀刻溶液之一。它是由体积比为6:1的40% NH4F水溶液和49% HF水溶液混合而成。缓冲氢氟酸的腐蚀速率为200纳米/分钟。
湿法刻蚀也是刻蚀硅的常用方法。如上一节所述,TMAH、KOH、EDP都可以用作湿法蚀刻溶液。
蚀刻停止技术
对于各向异性蚀刻,有时需要相应器件的特定厚度。已经提出了几种方法来使蚀刻厚度和图案尺寸可控。用于湿法蚀刻的横向尺寸控制使用硅(诸如SiO2或Si3N4的蚀刻掩模,因为方向相差两个数量级。对于垂直方向,时间控制、硼掺杂控制和锗掺杂(SOI)控制[27]是最常见的阻止硅蚀刻的方法。
时间控制是停止硅腐蚀的最廉价和最方便的方法。这种方法有两个主要缺点。首先,不能精确计算溶液中硅的蚀刻速率。其次,表面粗糙度不如其他两种蚀刻停止方法。但是,如果不需要精确的蚀刻厚度,这种方法很好使用。
不同温度下的硅腐蚀
我们华林科纳利用微细颗粒对湿法腐蚀的温度依赖性进行了研究。蚀刻剂使用100份25 % TMAH溶液中的20份IPA,温度范围为60至78℃。每个实验的蚀刻时间为10分钟。图3.4显示了不同温度下蚀刻硅的SEM图像。图3.5显示了鳍片之间蚀刻区域的AFM图像。1 × 1 和5 × 5 的扫描尺寸用于AFM测量,每次扫描的扫描分辨率为512×512数据点。RMS粗糙度如图3.6所示。从SEM图像中我们看到,由于硅的各向异性蚀刻,在所有情况下都获得了垂直侧壁。由于光刻偏置和蚀刻偏置引起的底切,鳍比掩模上的图案窄。
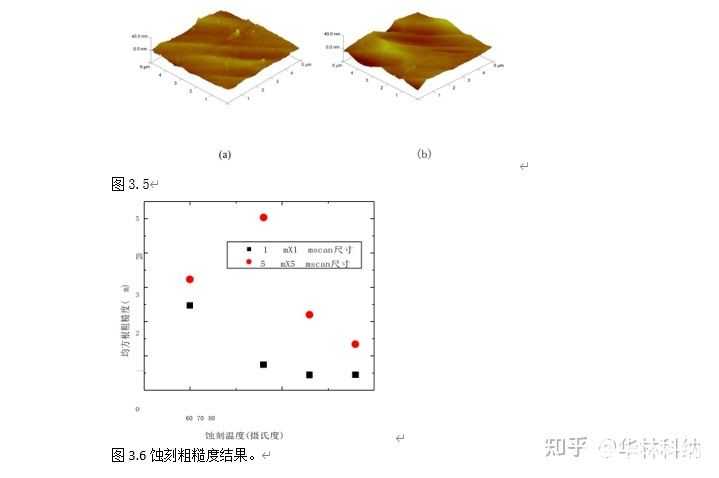
审核编辑:汤梓红
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)