
介绍
在IC制造中,从晶圆背面(BS)去除颗粒变得与从正面(FS)去除颗粒一样重要。例如,在光刻过程中,; BS颗粒会导致顶侧表面形貌的变化。由于焦深(DOF)的处理窗口减小,这可能导致焦点故障,如图1所J 示。随着特征尺寸的减小,这个问题变得更加严重。BS颗粒可能在湿工作台引起其他问题,其中BS颗; 粒可能转移到邻近的晶片前侧。图2显示了这些FS颗

BS颗粒的典型来源是利用静电或真空吸盘进行的晶片 处理,或者来自真空室中的板和工作台,这导致如图3所 示的缺陷图。对于预光刻BS颗粒清洗,这些颗粒主要在 电介质沉积、金属溅射或注入/灰化过程中产生。
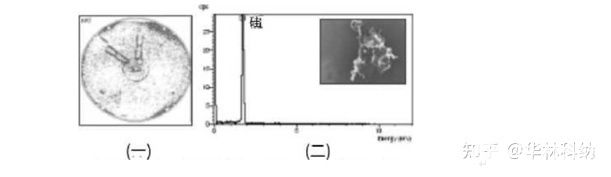
由于真空过程中典型的高温,颗粒会强烈地粘附在复 合物上。晶片背面。
用于先进器件制造的浸入式丸刻的引人带来了对松散膜 和颗粒的存在的更多关注,这些松散膜和颗粒会积聚在 晶片边缘(斜面和顶点)。晶片在设备流程中经历多个晶片 处理步骤,并且在每个步骤都会引入污染。由于扫描仪 的高处理量要求,浸没罩水层以大约0.5m/秒的速度移动 ,这从水弯月面的后缘移到邻近的晶片前侧。

实验在300毫米AK rion Systems gold finger velocity TM工具上进行。
兆频超声波声能通过塑料覆盖的压电材料直接传 递到晶片背面,到达由安装在晶片下面的BS兆频 超声波系统(BS Meg)提供的液体弯液面路径。BS Meg和晶圆背面之间的BS Meg弯月面的图片和声 音传输示意图如图5所示。
对于颗粒去除实验,在晶片翻转后,用Si3N4颗粒(直径200nm,每个晶片约20, 000个 颗粒)或在金属臟射室中污染300mm裸硅晶片。 在污染之前和之后以及清洗之后,通过SP2(KLA- 腾科公司)从65纳米尺寸幵始计数晶片上的颗粒数 量。
结果和讨论
正面和背面颗粒去除
SisN4颗粒的效率作为BSMeg功率和时间的函数 通过以下方式进行评估将稀释的SCI分配到薄饼上。图6显示了带有BSMeg和SCI的背面PRE在70W和30秒时已经达到85%以上条件下,BSMeg的背面PRE几乎比金手指的BS PRE高7倍 前端兆频超声波系统(FSMeg)。前面 如图7所示,使用任何一种兆频超声波,侧面• PRE是可比较的。这表明BS Meg能够清除两者 中的颗粒
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)