
TCP: 薄膜编带封装
TCP, 被称为薄膜编带封装, 这种工艺是把大规模集成电路芯片或者一般集成电路芯片安装固定在薄膜或狭带上。这是一种很薄且多管脚芯片的理想封装形式。封装类型为芯片表面只由树脂浸透的单侧罐封型。
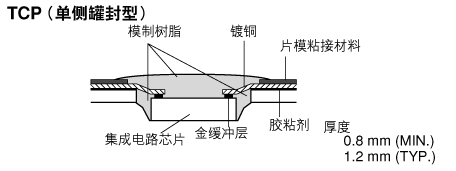 screen.width-500)this.style.width=screen.width-500;">
screen.width-500)this.style.width=screen.width-500;">SOF:薄膜上系统
裸芯片和外围元器件可以安装在薄膜上。这种非常柔软的薄膜封装较易弯曲,有助于设计扁薄小巧的产品。
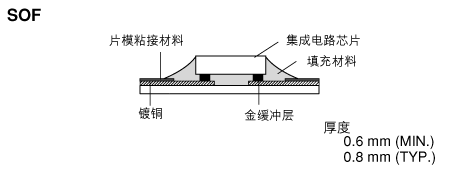 screen.width-500)this.style.width=screen.width-500;">
screen.width-500)this.style.width=screen.width-500;">CSP: 芯片尺寸封装形式
FBGA(通常称作CSP)是一种在底部有焊球的面阵引脚结构,使封装所需的安装面积接近于芯片尺寸。这种高密度、小巧、扁薄的封装技术非常适宜用于设计小巧的手持式消费类电子装置,如个人信息工具、移动电话、摄录一体机、以及数码相机。
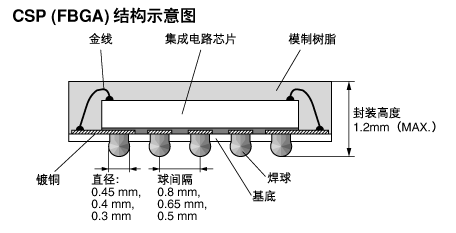 screen.width-500)this.style.width=screen.width-500;">
screen.width-500)this.style.width=screen.width-500;">叠层系统集成封装
叠层CSP、TSOP、QFP*和QFN是一种高密度芯片尺寸封装方式,许多大规模集成电路(LSI)用夏普独创的安装技术叠层组装到同一个封装之中。
用这种结构可以将多个器件组装在一起,如多个存储器芯片(例如,瞬时存储器与SRAM存储器)、AS集成电路芯片与存储器芯片等。它可以使手机、个人信息工具、以及其它便携式设备具有更多的功能,并且缩小体积、减轻重量。
叠层封装(CSP)
特点
· 丰富的产品系列
可提供品种丰富多彩的叠层CSP,包括2芯片、3芯片和4芯片的叠层CSP,以满足客户需求。
· 小的更薄的尺寸
将多块裸芯片装入一个目前的塑料封装中能减少安装所需的面积,而且使用夏普的更薄晶片技术能使封装高度最大为1.4mm。
· 多功能
不同大小、不同功能的多块裸芯片,例如逻辑LSI和存储器芯片,可以装入到同一个封装之中,从而可以获得多种功能。
· 相同尺寸芯片叠层技术
夏普的叠层技术使多块相同尺寸的裸芯片可以堆叠在一起,从而获得更高的存储密度。
(4芯片叠层 CSP)
使用夏普4芯片叠层CSP,装配和封装高度与使用2芯片叠层CSP或者3芯片叠层CSP以及通常的CSP相比能降低一半。
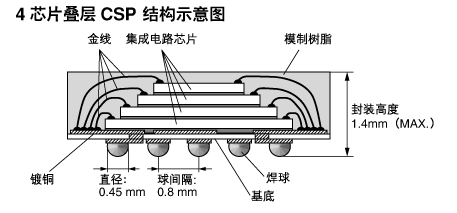 screen.width-500)this.style.width=screen.width-500;">
screen.width-500)this.style.width=screen.width-500;">欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)