
引言
随着硅基板越来越密集和复杂。为了提高基板的可靠性和执行能力,要求硅基板更高的清洁性。因此,为了在液/持续时间和液/液之间界面的完美调节下使基板表面清洁和均匀,了解基板污染物,查明机制,确立适当的基板污染剂那里技术是很重要的。硅表面的金属杂质给半导体装置带来不可治愈的损伤,如p/n粘合部漏电的增加以及异常电压的发生和载体寿命的减少。为了防止这种损伤,即使很少,也要将硅表面的金属污染降低到标准以下。目前,在通过干燥工艺去除硅基体表面的金属杂质和损伤方面,湿式工艺是唯一的。因此,进一步提高工艺很重要。
实验
在BHF和硅衬底之间的界面上,对金属杂质的分离和去除进行了实验,利用了可以直接与表面结合的铜。在金属杂质的硅表面,沉积有两种机制。第一次机械主义是终止硅表面的氢原子和金中离子之间的电荷交换引起的直接沉积。另外一种机制是氧化物在硅表面形成。金属杂质是沉积的金属氧化物,包含在硅中的时候。硅中含有的金属杂质可以通过将硅胶蚀刻为DHF来去除。去除直接与暴露的硅表面结合的铜等金属杂质不是一件容易的事。
表1解释了样品基板是如何制造的。在BHF吸收一定时间之前,用RCA清洗处理。RCA清洗后基板表面的初始金属污染程度低于标准污染期板调整的TRXRF的污染极限水平。然后基板用超纯水冲洗,最后用超纯水氮干燥。

表1 实验步骤
TRXRF是为了在制造的基板表面测量金属农度而写的。分别用AFM评价硅表面的微形貌。为了测量蚀刻率,基板表层的一半涂上有机形式的钝化膜,整个表面为DHF。用DHF-H202或BHF书写。去除霸屏膜后,用接触角测量仪测量了基板两半之间的氧化物厚度。
结果和讨论
DHF中铜的分离:
图1作为DHF浓度的函数,表示铜的电沉积性。在本实验中,各种硅基板在10分钟内以10ppb的铜离子在DHF上吸附。垂直轴表示从DHF转移到基板表层的铜的浓度。数平轴表示DHF的浓度。“n”代表n型室的鼻锥体表面。DHF中铜浓度固定为10ppb,而HF浓度为0.05、0.1、0.2、0.5 变成了5%。即使改变了HF的浓度,所有硅表面的铜电沉积也没有出现什么差异。用10分铜内lOppb的铜离子,n+-型硅表面在DHF中电沉积时被铜污染了。
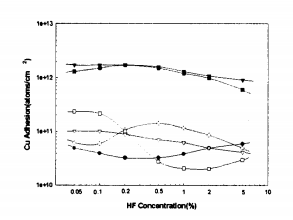
图1 六种不同硅表面上的铜偏析是受光照环境下铪浓度影响的函数
在这种方法中,沉积在基板上的金属被电离去除。这种清洗对去除吸收的金属有一定的疗效,就像硅基底上因为这种清洗而稍微被称为一样。但是在两种清洗方法中,溶液必须加热到约90℃。
DHF-H202内铜的分离:
表1出现的典型HC1-H202-000-000清洗可以去除硅基底上的金属杂质。HF-H2O2清洗常温下去除硅衬底表面吸收的金属污染物醇的多种方法,该方法具有HF刻蚀氧化物时H2O2同时在硅表面形成相同氧化物的机制。这种溶液去除了它在硅衬底上蚀刻时吸收的金属。在这个实验中,N型和P型基板被0.5% DHF吸收1分钟,以去除金属氧化物,然后用超纯水行进。接下来,这块基板与1ppm的铜一起,在纯水中浸泡10分钟后,用超纯水行进了约10分钟。这样,棋板的整个表面被1013~1011 atom/cm²左右的铜污染了。这种程度的铜污染是机板清洗前的初期污染水平。
图2是n型和p型硅基底为1ppm含有铜离子的DHF:0.5%。H2O2:用10%痕合液处理时,铜的电沉积浓度的变化性。这表明,即使混合液中含有1ppm的铜离子,铜也不会交叉污染n型或p型硅衬底片,而是从表面去除。这是实际制造过程中的DHF-H2O2溶液(DHF :0.5%,H2O2:10%)有助于清洁硅表面。也就是说,在润湿洗涤过程中,它保护了CAST内前后基板的交叉污染。
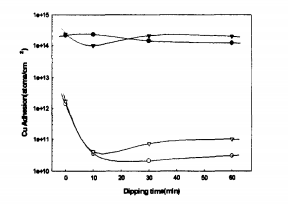
图2 铜污染物的去除效率
硅衬底表面施加BHF的界面成色剂内金属杂质的去除:
BHF是用来蚀刻厚氧化物的,这种氧化物相当于嵌在人体内的双层薄膜。跟着露出的硅表面是在蚀刻的最后阶段生成的。如果BHF所暴露的硅表面含有容易分离的铜等金属。这些金属从BHF溶液分离到硅表面。如果在BHF中添加适当的表面活性剂。硅衬底的润湿性提高,硅之间的蚀刻速度选择性提高。P+-型硅衬底在没有添加表面活性剂的BHF中也只有少量被铜污染。在添加了表面活性剂的BHF中没有受到污染。
总结
硅衬底表面的金属污染对半导体装置造成致命损伤。为了防止装置特性的低下,硅衬底上的金属电沉积农度必须降低到低下。目前,湿式工艺中的精密清洗是充分去除硅表面金属杂质所需的工艺。另外,超纯水中含有的金属杂质和化学物质不能污染基板表面醇。对于N型和P型表面,DHF-H2O2清洗在常温下去除与硅表面直接结合的金属杂质,效果良好。这种房间法不会带来可感知的交叉污染。
因此,DHF-H2O2清洗是N型和P型硅基板的最佳清洗方法。但是,n*-型和p*-型基板在DHF-H2O2用液中也容易受到铜交叉污染。n型基底上的n*-型表面和p*-型表面的表面微粗糙度在DHF-H2O2溶液内增加。在n*-型硅表面,DHF-H2O2溶液的IE的蚀刻率高于其他硅表面。DHF-H2O2清洗对从要求相当清洁的N型和P型硅表面去除金属杂质有效。但是,DHF-H2O2清洗不适合清洗具有n*-型和p*-型表面的基板。目前,要去除这些基板上的金属火纯品,需要NH/OH-H2O2-H:O清洗科HC1-H2O2-H2O被要求清洗。添加在BHF上以提高硅表面润湿性的碳氢型表面活性剂为N型。p型。对抑制高p*-型基板表面上的铜沉积有效。最终洗涤阶段适用的超纯水和DHF-在H2O2溶液内,可以通过交换硅和电电荷来浸泡的铜等金属,可以抑制在ppt单位以下。
审核编辑:符乾江
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)