
摘要
本发明提供一种能够提供低位错缺陷的高质量衬底的单晶碳化硅锭,和由此获得的衬底和外延晶片。
它是一种包含单晶碳化硅的单晶碳化硅锭,该单晶碳化硅含有浓度为2X1018 cm-3至6X 1020cm-3的施主型杂质和浓度为X1018cm-3至5.99 X1020 cm-3的受主型杂质,其中施主型杂质的浓度大于受主型杂质的浓度,且差值为1X 1018cm-3至5.99 X 1020cm-3。
发明阐述
在单晶生长过程中,由于作用在单晶碳化硅上的热应力而在单晶碳化硅滑移中发生的基平面易位移,这种滑动增加了基平面易位移的密度。因此,在生长过程中减少作用于晶体的热应力对于减少单晶碳化硅中基平面位错的发生是必要的。虽然各种创新和改进都集中在最小化热应力上,但在一个利用热梯度来驱动晶体生长的系统中,所允许的最小化程度是有限的。本发明是根据这些电路制造的,旨在提供一种能够提供基面位错低质量基板的单晶碳化硅锭,以及由此获得的基板和外延晶片。
实施发明
本发明的单晶碳化硅本发明的单晶碳化硅锭含有2x10“厘米至6x10厘米的供体型杂质和1x10厘米至5.99x10厘米的受体型杂质的串联束大于受体型杂质,差异为1x10”厘米至5.99x10‘厘米。因此,可以减少单晶碳化硅中的位错缺陷的数量。首先说明本发明单晶碳化硅锭的生产方法。在生产本发明单晶碳化硅的方法中,通过将单晶碳化硅生长在由单晶碳化硅组成的种子晶上的2x10厘米~6x10厘米的供体型杂质和1x10厘米~5.99x10厘米的供体型杂质,供体型杂质的浓度大于1x10厘米~1.99x10厘米的工艺,产生碳化硅大块单晶锭。发明者进行了大量的晶体生长以控制供体型杂质浓度和受体型杂质。
讨论
本节讨论降低基平面位错穴穴强度的机理。在单晶碳化硅生长过程中,基面位错密度变得很高,因为正如前面所指出的,位错经历了滑移,从而增加了Frank-Read型位错的发生。这种位错的滑移是由生长过程中作用于单晶碳化硅的热应力驱动的。然而,如上所述,热应力的程度是有限的。发明人研究了如何通过降低热应力以外的方法来控制位错滑动。一种用于抑制金属晶体中的位错滑移的方法是在晶体中添加一种杂质,从而固定位错。因此,研究了氮,一种通常添加到单晶碳化硅中的供体型杂质,是否表现出这种钉扎活性。然而,没有效果。
工业实用性
本发明能够获得优质的低位错缺陷的单晶碳化硅。其效果随着钢锭直径的增大而尤为明显。使用从这种单晶碳化硅中切割出的基质、基质和外延晶圆,可以制造高频、高击穿电压电子器件和在光学适当连接方面优异的蓝色发光器件。
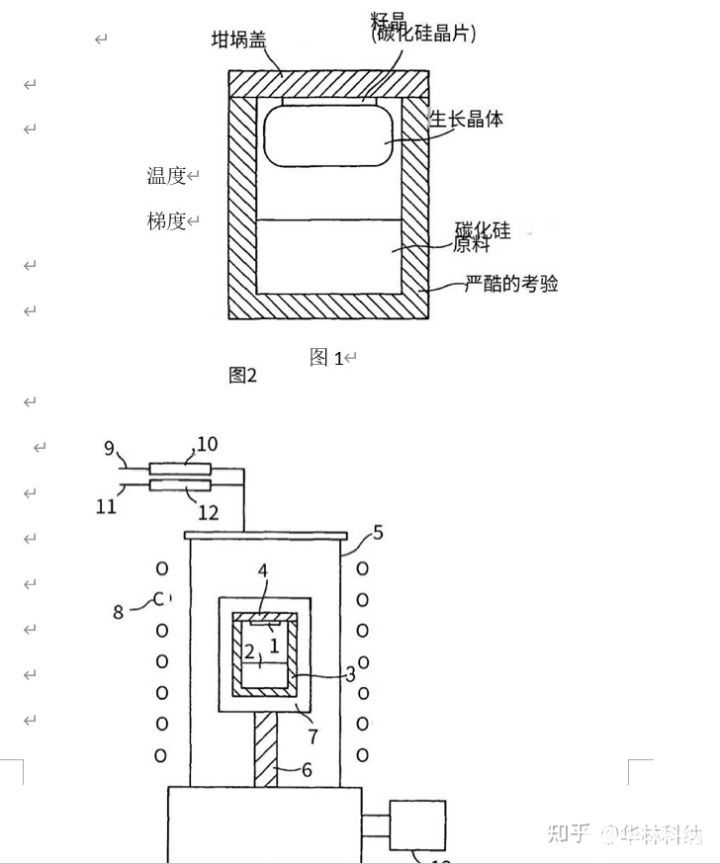
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)