
摘要
研究了高频和高频/HCI溶液中的不同平衡点,并研究了SiQ的蚀刻反应作为高频溶液中不同物种的函数。基于HF二聚体的存在,建立了一种新的SiO~蚀刻机制模型,
SiQ在高频溶液中的溶解是在集成电路制造的一个基本步骤。Mat和Looney~研究了二氧化硅在高频溶液中的蚀刻速率作为浓度、温度、氧化物生长过程和溶液搅拌的函数。
介绍
稀释度高频解中的平衡点
在稀高频溶液中,高频=H++F([3]HF+F-=;对于平衡常数(反应r~和r2的1和K2,其值分别为6.8510 4 工具/l和3.963l/工具。~这些是25~处的平衡常数,并为零离子强度进行校正。我们表明,稀高频溶液中的离子强度非常低,因此可以使用这些值。此外,由于离子强度较低,计算可以用浓度而不是活性来进行的。项研究表明,必须考虑(HF)2F-、(HF)3F-和(HF)4F的形成,以解释观察到的高频溶液的酸性,而不是仅从反应r~和r2的平衡中得到的酸性。同样,Farrer和RossotTI6早期表明,(HF)2F-、(HF)3F-和(HF)4F-在高达1MHF的HF溶液中不存在。此外,对于推导SiQ的蚀刻机制,0~1M的区域是最敏感的。

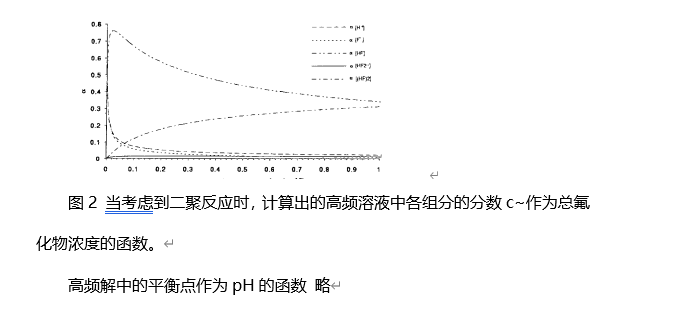
实验
侵蚀率的研究与建模
氧化物在1000~的干燥O2中生长蚀刻溶液在室温下(19~在可控洁净室环境中9对于每个浓度,应用三次不同的蚀刻时间,在125毫米晶片上的49个点上测量蚀刻厚度,然后通过这些点的斜率和初始厚度获得蚀刻率。在任何情况下,都没有观察到耗尽或扩散限制的状态,因为测量点从未偏离直线。这条线与49个点总是被测量的事实相结合,可以得到可靠的蚀刻率数据。在晶片上的空间变化始终为<为0.2nm,在HF/HC1溶液中<为0.15nm。为了研究蚀刻机理,最好绘制相对蚀刻速率,即蚀刻速率除以正式的氟化物浓度。这表示每摩尔氟化物的蚀刻率作为总氟化物浓度(或正式的高频浓度)的函数。这是如图所示。用于HF和HF/HC1溶液。从这些测量中,每个组件的蚀刻率可以通过拟合蚀刻率作为成分的函数来确定
结论
考虑了HF(HF)~二聚体的蚀刻,建立了一种新的蚀刻SiQ蚀刻模型。研究了高频溶液的组成与总氟化浓度的函数和pH的函数。通过本研究,得出了不同的蚀刻机制,并确定了它们作为总氟化物浓度的相对重要性。已经准确地描述了高频溶液与SiQ的蚀刻反应,这在整个浓度范围内都是有效的。在高频溶液中存在两种主要的蚀刻物种。第一个是HF的二聚体,(HF)2,第二个是HF的双氟化物离子,HF~。只有2或4F原子的出现才能启动蚀刻9最后,我们发现低浓度的HF2-蚀刻会导致蚀刻速率的差异增加。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)