
目前汽车安全产业需要降低元件数的小型组件,缩小尺寸及减少元件数的需求,促使半导体供应商加入更多耗电的功能,造成元件温度升高,降低稳定性,同时也影响汽车安全。若在设计阶段早期优化晶片配置及电源脉衝时间,设计人员即可降低硅测试次数,缩短开发时间。本文首先将说明半导体散热封装的功能,与如何使用模型模拟软体协助电源元件及系统设计,包括一般汽车设计难题的讨论、模型建立技巧、散热模型验证及系统提升。
汽车电子产品产业使用各种半导体封装,封装类型从小型单一功能电晶体,到100多个接脚及特殊散热功能的复杂电源封装等。半导体封装能够保护晶粒、提供装置与系统外部被动元件之间的电子连接,并管理散热。本文将讨论半导体封装如何让晶片散热。
在接脚封装(leaded package)中,晶粒黏着于晶粒座的金属片上。这个晶粒座在构装期间支撑晶粒,并提供良好的热导体表面。在汽车产业中,常用的半导体封装类型是外露焊垫封装(exposed pad),也就是PowerPAD封装。在这类封装中,晶粒座的底部外露,直接焊接于印刷电路板(PCB),使晶粒直接散热至PCB,透过焊接于电路板的外露焊垫向下散热,然后透过PCB散热至环境中。
外露焊垫封装能够透过底部,将80%的热度散入PCB。另外20%的热度则从装置接脚及封装侧边散出。只有不到1%的热度是从装置顶部散出。
非外露焊垫封装也是接脚封装,但晶粒座由塑胶完全包覆,无法直接散热至PCB。在标準接脚封装概念中(见图1),大约58%的热度是从接脚集封装各边散出,40%是从封装底部散出,大约2%是从封装顶部散出。散热透过叁种方式进行:传导、对流及辐射。对于汽车半导体封装,散热的主要是透过传导至PCB及对流至周围空气。辐射佔散热相当小的比例。
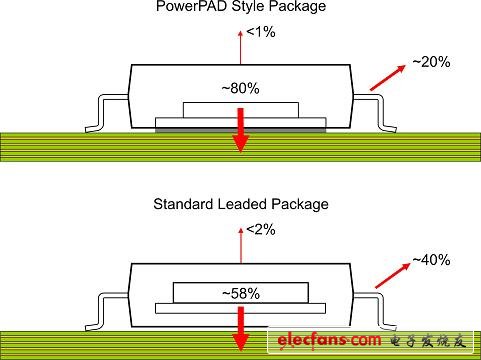
图 1. 标準接脚封装及 PowerPAD 封装的散热及散热途径。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)