
在今年的Imec技术论坛(ITF2017)上,Imec半导体技术与系统执行副总裁An Steegen展示最新的半导体开发蓝图,预计在2025年后将出现新工艺节点——14埃米(14A;14-angstrom)。这一工艺相当于从2025年的2nm再微缩0.7倍;此外,新的占位符号出现,显示工艺技术专家乐观看待半导体进展的热情不减。
Steegen指出:“我们仍试图克服种种困难,但如何实现的途径或许已经和以前所做的全然不同了。”
14埃米节点也暗示着原子极限不远了。单个砷原子(半导体所使用的较大元素之一)大约为1.2埃。
随着半导体发展脚步接近未来的14埃米,工程师们可能得开始在相同的芯片上混合鳍式场效晶体管(FinFET)和纳米线或穿隧FET或自旋波晶体管。他们将会开始尝试更多类型的内存,而且还可能为新型的非冯·诺依曼计算机(non-Von Neumann)提供芯片。
短期来看,Steegen认为业界将在7nm采用极紫外光(EUV)微影技术、FinFET则发生在5nm甚至3nm节点,而纳米线晶体管也将在此过程中出现。
如今,14埃米节点还只是出现在PPT上的一个希望 (来源:Imec)
Steegen表示:“从事硬件开发工作的人员越来越有信心,相信EUV将在2020年初准备好投入商用化。经过这么多年的努力,这一切看来正稳定地发展中。”
Imec是率先安装原型EUV系统的公司,至今仍在鲁汶(Leuven)附近大学校园旁的研究实验室中持续该系统的开发。
Steegen预计,EUV“将在最关键的层级导入工艺,”以便在线路终端处完成通道和区块。使用今天的浸润式步进器,这项任务必须通过3或4次的步骤,但透过EUV更精密的分辨率,只需一次即可完成。
工程师在这些先进节点上工作时,必须先检查其设计能够搭配使用浸润式或EUV系统。当他们在将芯片发挥到极致时,将会使用EUV更进一步缩小其设计。
无论如何,还需要3或甚至4次的浸润式图案化过程,才能打造具有小于40nm间距的特征尺寸。工程师不要指望设计规则能很快地变得更简单。
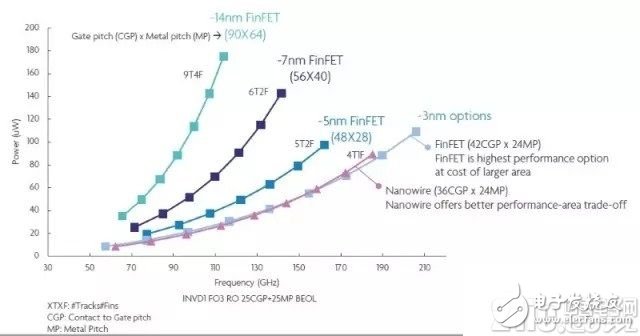
Imec勾勒未来节点可能实现的功率性能
选择抗蚀剂与晶体管
找到合适的抗蚀剂材料是让EUV顺利量产的几项挑战之一。到目前为止,如果研究人员能以20毫焦耳/平方公分的曝光能量进行,就能使EUV顺利进展。
包括ASML、东京电子(Tokyo Electron)和ASM等几家公司正在开发专有(意味着昂贵)的技术来解决问题。它们通常涉及了抗蚀剂处理以及多个工艺步骤,才能蚀刻或退火掉粗糙度。
“这项技术看起来非常有希望,所以我们有信心能够克服线边粗糙度(LER)的问题,”Steegen说。
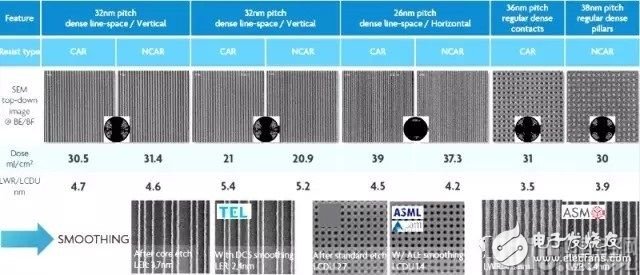
此外,Imec现正开发保护EUV晶圆免于污染的防尘薄膜。它以碳纳米管提供承受EUV曝光超过200W以上所需的强度,而非阻挡大部份光源穿透晶圆。
除了EUV以外,下一个重大障碍是基本晶体管的设计转变——任何组件核心的电子开关。Steegen说:“FinFET的微缩是必须解决的关键问题。”
截至目前为止,研究显示,FinFET可以在5nm时使用,而如果导入EUV的情况顺利,甚至可沿用至3nm节点。Steegen说:“在3nm节点,FinFET和纳米线的效果能几乎一样好,但纳米线闸极间距带来了更多的微缩,”他并展示一项堆栈8根纳米线的研究。
详细观察阻抗剂的问题显示,使用化学助剂和不使用化学助剂(CAR和NCAR)的研究结果。LWR/LCDU是指线边粗糙度的测量值应不超过特征间距尺寸的十分之一,图中的范围约为3.2至2.6。
信道微缩与内存
如果EUV一再延迟,芯片制造商将会调整单元库来缩小芯片。Imec正致力于开发一个3轨(3-track)的单元库,这是将芯片制造商目前用于10nm先进工艺的7-track单元库缩小了0.52倍。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)