
氮化镓功率器件由于其优异的性能而被用于越来越多的应用中。本文解释了要考虑的主要特征。一项可能的研究是将 GaN 用于低温应用,例如航空、太空和超导系统,特别是在不同电路配置中低于液氮温度 (77 K) 的工作条件。在本文中,报告了一些关于低温环境中不同开关和电压损耗配置的研究。作者研究了四个商用 GaN 器件在 400 K 和 4.2 K 之间的宽温度范围内的性能。据作者介绍,正如原始文章中所报道的,所有测试的器件都可以在低温下成功运行,性能整体有所提高。然而,不同的 GaN HEMT 技术意味着器件栅极控制的显着变化。
GaN HEMT
在本博客中,我们讨论了 GaN 在温度接近 150˚C 的各种应用中与硅相比的改进性能。然而,许多应用需要能够在低至几开尔文的温度下运行的设备——考虑新能源用途、能量存储、超导体以及航空和太空应用。
随着成本和结构复杂性的大幅增加,电力系统通常被绝缘并保持在环境温度下。因此,直接在相关温度下运行系统将是非常有利的。
当硅和宽禁带器件(如碳化硅和垂直 GaN)的温度下降时,会出现两个重要现象,如文章中所述:载流子迁移率随着高性能参数电子-声子相互作用的降低而上升。此外,这种下降反映在载流子密度的下降中,这导致沟道电阻的增加和向正阈值电压 (V th ) 水平的转变。
由于载流子是由 AlGaN 势垒和 GaN 层之间的极化失配产生的,因此 GaN HEMT 不需要任何掺杂即可在沟道中获得高浓度的电子。温度与这种情况无关。
商业器件( EPC和GaN 系统)的特性评估已发表在多篇研究论文中,证明了在 77 K 温度下性能的提升。这项工作的作者着眼于标准 GaN 拓扑的性能,包括栅极注入晶体管(GIT) 和级联,以及器件传导和软开关和硬开关损耗等特性,从 400 K 到 4.2 K。原始 IEEE 文章中考虑的器件如图 1 所示。
图 2 显示了作者用来进行测量的方案。使用 PID 控制器,温度在 400 K 和 4.2 K 之间变化,公差为 0.1 K,测量在真空条件下进行(10E-4 mbar,300 K)。
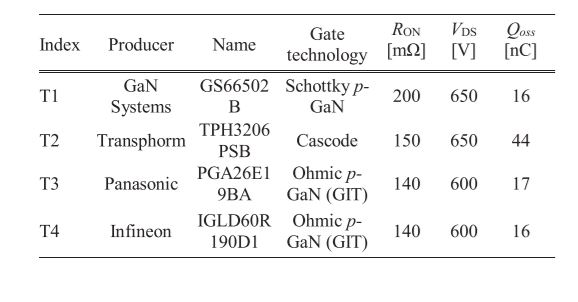
图 1:用于测量的 GaN 器件

图 2:(a) 用于器件表征的低温探针台;(b,c) GaN 器件的电路/示意图(来源:IEEE)
基本上,描述和比较了四种商业设备,每一种都具有相同的电流和电压,但设备技术不同。为了同时提供直流器件和开关特性,采用了两个晶体管。一个 10nF(多层陶瓷)C ref电容器连接到一个器件的栅极和源极端子,以执行 Sawyer-Tower (ST) 测试以评估器件开关损耗(图 2)。有关 ST 方法的更多详细信息,请阅读本文。

图 3:(a) T3 从 400 到 4.2 K 的传输特性;(b) V th作为四个器件的温度函数;(c) 比较器件的导通电阻与温度的关系;(d)关于四个器件的室温值的归一化 R on (来源: IEEE)
从作者的研究中,可以在图 3 中观察到传递函数,以及因此特性的正向偏移。另一方面,基于 1mA I ds的阈值电压表明解决方案之间存在显着差异。随着温度下降,GIT 器件(T3 和 T4)的 V th保持相对恒定但缓慢上升。级联共栅显着上升,但电路的d性使其能够以高栅极电压 (V g ) 驱动,以补偿 V th漂移。V thT1 从环境温度下的 1.6 V 下降到 4.2 K 下的 1 V。这种影响可能会导致更小的“关闭”状态余量,从而减少误报。这种效果可以确保减少“关闭”状态裕度,从而在这些条件下产生误报。
图 3c 中看到的温度下降表明器件的导通电阻降低。这是由于电子迁移率增加导致电阻降低。然而,这四种设备的行为不同,表明它们都与 HEMT 技术相关,正如作者实现的归一化值(图 3 中的 d)图所示。技术之间的这种行为差异对器件传导、损耗和驱动电路有直接影响。
根据电路的工作条件,器件会受到软开关或硬开关损耗的影响。Soft 通常以 ST 测量为特征,并与器件输出电容 (C oss )的非理想充电和放电有关,并且在高频下变得很重要。参考电容器上的电压 (V ref ) 的测量允许获得 Q oss ,因此考虑到充电和放电路径之间的滞后循环,在每个开关周期 (E diss )消耗的能量。
正如文章中所指出的,它们的反应都不同,这意味着这种差异与捕获位点的特定能级紧密相关。由于每个制造商经常使用自己的结构,因此开关损耗值和温度特性应根据所使用的 GaN 缓冲混合物和 Si 衬底而有很大差异。这组作者说,与传导损耗相比,软开关损耗具有中等的温度依赖性。
在这种情况下,很难测量硬开关损耗。主要贡献由f × E oss表示(其中f是开关频率,E oss是在“关闭”状态下某个值 V ds时存储在晶体管输出电容中的能量)和另一个与C oss放电期间从电路流过器件通道的外部负载电流。如原始文章中的图表所示,E oss对硬开关损耗的贡献在很宽的温度范围内是相当恒定的(T4 的变化更大)。
从分析中可以看出,所有测试的设备都可以在低温下运行。不同的 GaN HEMT 技术经历了设计过程中需要考虑的变化。
审核编辑:刘清
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)