
合金化热处理
合金化热处理是一种利用热能使不同原子彼此结合成化学键而形成金属合金的一种加热工艺,半导体制造过程中已经使用了很多合金工艺,自对准金属硅化物工艺过程中一般形成钛金属硅化合物(见下图)。
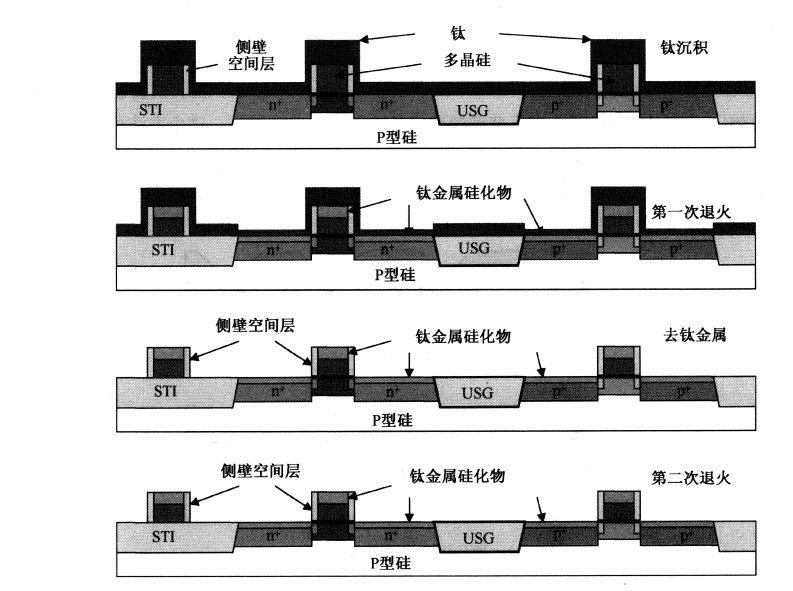
第一次退火在较低的温度(约650摄氏度)和氮气环境下进行,形成晶粒较小而电阻系数较高的049钛金属硅化物。第二次退火是较高温(超过750摄氏度)的工艺过程,并将电阻系数较高的C-49转变成电阻系数较低的C-54 TISi2o虽然有可能只用一次高于750P的退火处理直接形成C-54TISi2,但可能造成源极/漏极与栅的短路。这是因为高温下硅在钛金属内的快速扩散将导致钛金属硅化物桥接电介质侧壁(称为硅压入效应)。
钻硅化物的形成过程和钛金属硅化物类似。第一次退火是在450Y形成CoSi;第二次退火是在700摄氏度下形成CoSi2o如果使用RTP技术就可以在700 ~750摄氏度下直接一次形成CoSi2o以及在0. 25um~90 nm工艺技术中广泛使用。
65 nm节点之后,已经将镣硅化物作为硅化物材料用于高速逻辑IC中。NiSi可以在约450Y的较低温度下形成,从而减少了热积存。
高温炉和RTP系统都用于钛金属硅化物和钻金属硅化物的合金工艺中,然而RTP有较好的热积存控制和晶圆对晶圆的均匀性。高温炉已在400摄氏度和充满氮与氢气的环境下用于形成铝硅合金,这样的低温可以防止硅铝交互扩散造成所谓的结面尖凸现象(见下图)。

再流动过程
当温度超过硅玻璃的玻璃化温度(Glass-transiTIon Temperature)时,玻璃就会软化并开始流动,这种特性被广泛应用于玻璃产业中将玻璃塑造成各种形式的玻璃制品。这个方法也应用在晶圆制造中使玻璃表面在流动的高温中变得更加平滑。1100摄氏度时,掺磷的硅玻璃(PSG)将会软化并开始流动。软化后的PSG沿着表面张力流动使电介质表面更加圆滑平坦,从而可以改善光刻工艺的解析度并使后续的金属化更加顺利。下图显示了PSG沉积和再流动的情况。

随着最小图形尺寸的不断缩小,热积存也更加紧凑。硼磷硅玻璃(BPSG)可将再流动温度降低到900Y左右,从而显著减少了热积存。一般而言,再流动工艺需要在充满氮气的高温炉环境中进行约30 min(从推进晶圆载舟及温度上升到设定温度并达到稳定为止)。
当最小图形尺寸缩小到0.25um 以下时,再流动工艺已无法满足高光刻解析度对表面平坦化的要求,太过紧凑的热积存也限制了再流动的应用,所以化学机械研磨(CMP)技术取代了再流动技术应用在电介质的表面平坦化技术上。
高温化学气相沉积
化学气相沉积是一种添加工艺,将在晶圆表面沉积一层薄膜层。高温化学气相沉积(CVD) 过程包括外延硅沉积、选择性外延工艺、多晶硅沉积和低压化学气相(LPCVD)氮化硅沉积。
外延硅沉积
外延硅是一种单晶硅层,通过高温过程沉积于单晶硅晶圆的表面。双载流子晶体管、双载流子互补型金属氧化物半导体晶体管(BiCMOS)IC芯片,以及高速先进金属氧化物半导体晶体 管(CMOS) IC芯片均需要使用外延硅层。
硅烷(SiHQ)、二氯硅烷(DCS, SiH2Cl2)和三氯硅烷(TCS, SiHCl3)是硅外延生长中最常使用的三种气体。硅外延生长的化学反应如下:


通过将掺杂气体如三氢化铍(AsH3 )、三氢化磷(PH3)和二硼烷(B2H6)与硅的来源气体注入反应室,就能在薄膜生长过程的同时对外延硅掺杂,这三种掺杂气体都是有毒、可燃及易爆性气体。整面全区外延硅的沉积通常在IC生产之外的晶圆制造厂中完成。
审核编辑:汤梓红
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)