
为了阐明蚀刻残留物的形成机理,研究了氯/氦-氧、溴化氢/氦-氧和溴化氢/氯等不同气体混合物的影响,我们发现在氧的存在下,蚀刻残留物形成良好,这表明蚀刻残留物是由氧和非挥发性乳化硅化合物的反应引起的,湿法清洗和干法蚀刻清洗工艺被用于去除多晶硅蚀刻残留物,这可能影响电特性和进一步的器件工艺。XPS结果表明,湿法清洗适用于蚀刻残留物的去除。
本文利用HBr/Cl/He-O2反应气体对多晶硅进行反应离子蚀刻后,利用X射线光电子能谱(XPS)和电子显微镜(SEM)对表面形成的杯状流层进行了研究,为了查明蚀刻残留物的形成机制,从原来的混合气体成分中分别排除了一种成分的反应气体,观察了其效果。同时,为了消除使用HBr/CI/He-O2混合气体冷却后形成的残留层,引入了湿法和干式工艺进行了比较。
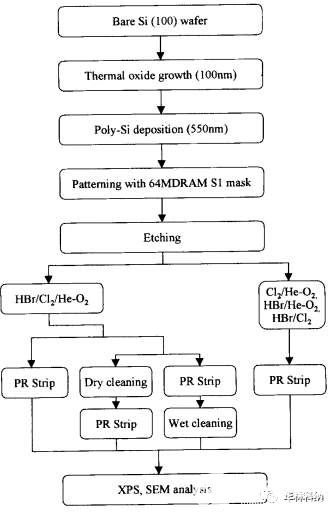
图1
图1是实验顺序的图表,首先,在生长了约100 nm厚的热氧化物的(100) p型硅晶片基板上,用LPCVD方法将多晶硅生长了约550 nm,然后,利用64 MDRAM S1口罩对准备好的基板进行图案设计,然后进行了蚀刻实验,蚀刻条件是RF功率为150 w,反应汉堡王的压力保持在100 mTorr,磁场保持在75 Gauss,在此条件下,蚀刻速率约为200 nm/ min。为了查明蚀刻残留物的形成机制,将原来的反应气体成分中的一个成分各排除在外,进行了进一步的实验,这时的混合气体是 氯/氦-氧(30/9 sccm)、溴化氢/氦-氧(30/9 sccm)、溴化氢/氯 使用了30/30 sccm),蚀刻条件如上。反应离子蚀刻后形成的残留层会影响后处理过程,因此,为了消除使用HBr/Cl/He-O2混合气体蚀刻后形成的残留膜,采用了湿法和干式工艺。
图2使用HBr/Cl/He-O:反应气体进行蚀刻 这是观察剖面的SEM照片,利用O2等离子体和O/H2SO 4溶液去除后,观察食各表面,发现残留物以囊的形式残留在多晶硅薄膜上。调查这样形成的残留物的组成元素和化学结合状态,为了起床做了XPS分析,首先,图3(a)的XPS survey光谱显示,残留物的成分包括硅(silicon)、氧(oxygen)、大气中的碳等。

图2
图3(b)中的Si2p和(c)中的 残留物 在O1s峰的NARROW SCAN SFETLAM中,可以观察到硅氧化物的化学键状态不止一种,这说明多晶硅蚀刻残留物膜的化学键形式是硅氧化物。其中,O1s和Si2p光谱中关于thermal oxide和看起来是蚀刻残留物的氧化硅峰的结合能差,这似乎是由于差分相位差异造成的,这反而有助于区分彼此。
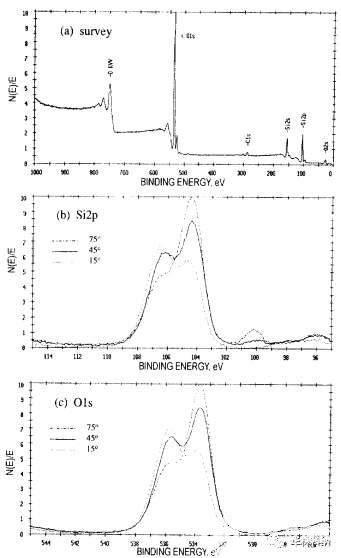
图3
为了确认在微分中分离的每一年的化学键状态,观察了沿着take-off angle的变化。图 3的(B)和(C)显示了随着takc-off anglc)的变化,每个化学键状态的峰值强度相对如何变化。利用蚀刻工艺,结果表明残留物以硅氧化物的形式存在于多晶硅的顶部,为了查明蚀刻残留物的形成机制,在原始HBr/CI/Hc-O2混合气体条件下各有一项 排除了的反应机理,进行了实验。为了重申最高结合能Si2p的106.2 cV和O1s的535.8 cV的化学键状态是由蚀刻残留物引起的,利用Ar '对深度方向进行了分析(depth profilc)。结果,20分钟冲刺后,被认为是蚀刻残留物,可以观察到很少发生。
从以上结果可以看出,在利用HBr/C/He-O、反应气体进行反应性连续蚀刻后去除残余物的后处理工艺中,为了使表面变得更加清洁,湿法工艺比干球信息更合适。通过x射线光电子能谱(XPS)的结果观察了流物的形成,因此,为了获得更干净的表面,可以得出湿工序比干工序更合适的结论。
审核编辑:汤梓红欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)