
本文介绍了一种新型的高纵横比TSV电镀添加剂系统,利用深层反应离子蚀刻(DRIE)技术对晶片形成图案,并利用物理气相沉积(PVD)技术沉积种子层。通过阳极位置优化、多步骤TSV填充过程、添加剂浓度和电镀电流密度优化,在保持无空隙填充轮廓的同时提高填充效率,通过tsv的晶片段电镀,验证了其可用性。利用线性扫描伏安法(LSV)、计时安培法和数值模拟方法研究了其作用机理。
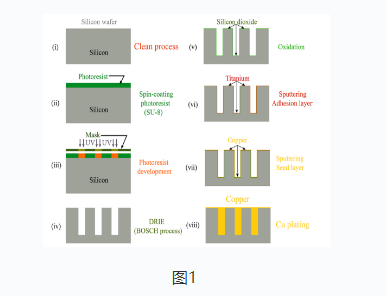
对于本文开发的原型器件,设计了四种图案晶片,其中包括050μmx 150μm,040μmx 140μm, 030umx 130μm,和020μmx 120um.的视孔如图1所示,TSVs通过六种工艺创建: (a)硅片清洗; (b)旋转涂层光刻胶(SU-8) ; (C)光刻抗蚀剂开发; (d)深反应离子蚀刻(DRIE) (博世工艺) ; (e)氧化获得二氧化硅阻挡层(提供TSVs之 间的电隔离) ; (f)溅射钛粘附层; (e)溅射铜种子层; (h)Cu-TSVs电镀。图2显示了使用玻色工艺蚀刻的透硅孔的扫描电镜显微图,图2(a)和(b)分别显示了tsv的顶视图和横截面SEM显微图,如图2(C), 所示扇贝的横向粗糙度小于100纳米。

利用商用的COMSOL多物理软件模拟了TSV中的电场分布,采用有限元法(FEM)建立了物理模型,在该模型中,与TSV的段晶片阴极对应的阳极位置是可变的(阴极的上、下或右侧)。
本文介绍了-种新型的用于填充高宽径比TSV的商业添加剂体系,碱电解质含有80gL-1Cu2+、20gL-1CH3SO3H和50mgL-1Cl-,提出了四种不同的创新方法来缩短填充时间。
电化学测量采用了-种标准的三电极系统,使用图案和固体平面电极作为工作电极(WE), Pt网用作对电极(CE),采用饱和热量参比电极(SCE)作为参比电极,本文给出的电位相对于SCE (0.242V相对于正常的氢电极(NHE) ),电镀电池中电解质的体积为250mL,由于扩散能力、添加剂消耗与电流密度之间的关系,电流密度影响填充模型和填充效率。在含有4ppmDVF-B、20ppmDVF-C和1.5ppmDVF-D的电解质中,不同电流密度下cu-tsv电镀的截面光学显微镜图像。
当同时加入三种添加剂(DVF-B、DVF-C、 DVF-C、 DVF-D)时, 电流密度对通过填充行为影响显著,当在电镀过程中施加较低的电流密度(3mAcm- 2)时,该抑制剂具有较弱的抑制作用,沉积速率缓慢,且抑制因子在通过底部区域的消耗量较小,更重要的是,有足够的时间让抑制剂扩散到通道的底部,添加剂的添加量(DVF-B、DVF-C和DVF-D)在通过深度方向上几乎相等,因此在低电流密度下,填充行为表现出保形填充特征。
在较高的电流密度(10-20mAcm- 2)时,沉积速率增加,抑制剂每秒的消耗量增加。虽然抑制因子的扩散系数是恒定的,但抑制因子没有足够的时间来扩散到通道的底部来补充消耗抑制因子,虽然加速的数量在通道内部的任何地方都是相等的(由于加速的扩散系数很大), 但抑制剂的剂量,由于抑制因子的消耗和扩散的限制,沿着通过深度方向显著减少,这种沿通过深度方向的添加剂分布导致了电镀的超填充类型。
从填充曲线上可以看出,在相同数量的电荷(Q=Ixt)下,铜沉积量(S)随着应用电流密度的增加而减少,这可能是由于电流效率(η) 的降低所致,这可能是由于抑制因子的抑制作用随着外加电流密度的增加而增加所致。
用固体平面电极和图案化电极测量的LSV曲线,分别大致对应于通道的顶部和通道的底部,通道底部区域的电流密度大于顶部区域的电流密度,通道底部和通道顶部的镀速率差小而小,在适当的电流密度(ca)下,通道底部和通道项部之间的电镀速率的差异显著增加,可以抑制通道中空的形成,以上讨论表明,适当的电流密度不仅避免了通过口中形成的接缝或夹口,而且提高了通填效率。
添加剂的浓度在通过充填过程中起着重要的作用,它影响了通过表面上的添加剂吸附解吸行为的随机概率,此外,随着吸附和消耗过程的进行,它影响了通道内部的生长速率,从而控制了Cu-TSV填充模型。当片段晶片在高添加剂浓度(6- 30ppm)的槽中电镀时,孔在同一周期内完全填充,而当添加剂浓度更高(50~ 80ppm)时,在同一电镀周期内出现部分填充轮廓。
本文介绍了四种优化方法来减少三维集成透硅通孔(TSVS)的填充时间,并利用线性扫描伏安法(LSV)和时安培技术对其机理进行了研究,对相对于tsv的阳极位置进行了优化,当阳极放置在tsv的前方、右侧和后方时,填充效率在一定程度 上依次提高,多步TSV填充过程表明,在从腔室和孔中去除空气之前,加入添加剂(DVF- B),TSV填充效率有效提高,填充效率随着预湿电解液中加速浓度的增加而提高,模拟了添加剂的表面吸附过程,对理解添加剂的吸附和填充过程具有很大的意义,添加剂的浓度在通过填充过程中起着重要的作用,这控制着Cu-TSV的填充模型。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)