
注:最终用户及安装人员应该负责提供其行业标准要求设计和装配文件,行业标准文件包括(但不限于)以下内容:
- 电子工业联接协会(IPC)
- 半导体标准行业协会(JEDEC)
- 电子工业协会(EIA)
- 国际电子制造联合会(iNEMI)
- 国际电工委员会(IEC)
- 美国国家标准学会(ANSI)
- Jisso国际理事会(JIC)
- 日本印刷电路工业会(JPCA)
- 线束及组件制造商协会(WHMA)
图1. 4 x 4 WL-CSP照片,减少了两个球栅阵列的位置,电路侧视图
WL-CSP封装技术最根本的优点是IC到PCB之间的电感很小,第二个优点是缩小了封装尺寸并缩短了生产周期,提高了热传导性能。
WL-CSP结构Maxim的WL-CSP球栅阵列是在硅晶片衬底上建立的封装内部互连结构。在晶片表面附上一层电介质重复钝化的聚合物薄膜。这层薄膜减轻了焊球连接处的机械压力并在管芯表面提供电气隔离。在聚合物薄膜内采用成相技术制作过孔,通过它实现与IC绑定盘的电气连接。
WL-CSP焊球阵列是基于具有均匀栅距的矩形栅格排列。WL-CSP球阵列可以包含任意行(2至6)和任意列(2至6)数。焊球材料由顶标中A1位置的标示符表示(见图2中的顶标A1)。A1为光刻的双同心圆时,表示焊膏采用的是低熔点的SnPb;对于无铅焊膏,A1处采用加号表示。
所有无铅WL-CSP产品底部的晶片迭层采用标准的聚合物薄膜保护层,该聚合物材料为硅片底部提供机械接触和UV光照保护。
WL-CSP球栅阵列设计和尺寸Maxim的WL-CSP 0.5mm间隔的球栅阵列封装通常设计为2 x 2至6 x 6焊球矩阵(图2),详细的WL-CSP尺寸图可从网站下载:Maxim封装图。根据特殊器件的设计要求,焊球阵列的也可能突破最大焊球数。
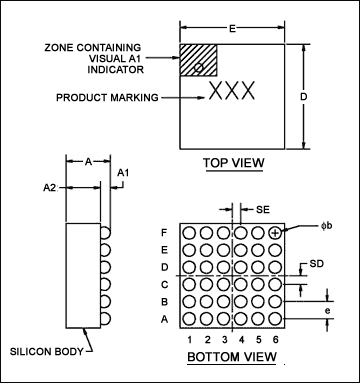
图2. 传统的的WL-CSP封装外形图,6 x 6阵列
WL-CSP载带参考文献:
- ANSI/EIA-481-1-A 8mm和12mm表贴元件卷带,用于自动处理流程。
- EIA/IS-763裸片和晶片级封装包装带,8mm & 12mm载带,用于自动处理流程。
- IEC60286-3自动处理流程元件包装—第3章:表贴元件的载带包装。
- 卷带的凹槽应该在元件周围提供足够的空间,以确保:
- 器件不会超出载带的上下任一个表面。
- 揭开封带时,元件不受任何机械力的约束,能从凹槽中垂直取出。
- 元件的旋转位置限制在±10°以内(见图3)。
- 最小半径R是体现包装带设计和材料机械弯曲特性的半径值。实际的卷带中轴半径必需大于最小值R。按照常规方向装有元件的卷带在弯曲半径大于最小值R时不会对载带和元件造成损害。用户应该对卷带在送料器和任意其它处理、运输、储存过程中的条件进行设置,使其弯曲半径总是大于最小值R。
- 条形码标志(如果需要)应该在载带与链轮齿孔相反的一侧,参见EIA556。
- 如果卷带凹槽的间隔为2.0mm,卷带可能无法合适地装进所有的送料器。
- 卷带包装里焊球朝下,包装带每一个凹槽的A1引脚方向保持一致。左上角有A1引脚位置的标记(图2)。
- 封带的总剥离力应该在0.1 N到1.0 N之间(标定刻度的读数为10克力到100克力)。拉力的方向应该与包装带移动的方向相反,封带与包装带成165°至180°角。在剥离的过程中卷带/封带的剥离速度应该是300mm ±10mm/分钟。

图3. 卷带内部允许CSP器件的最大旋转位置
WL-CSP封装的PCB安装流程及实施参考文献:
- IPC-7094关于倒装芯片及裸片的设计和安装流程
- IPC-A-600可接受的印刷电路板。
- IPC-6011关于印刷电路板的通用规格说明。
- IPC-6012关于刚性印刷电路板的认证和规格说明。
- IPC-6013关于柔性印刷电路板的认证和规格说明。
- IPC-6016关于高密度内部互连(HDI)板层或电路板的认证和规格说明。
- IPC-D-279关于表面贴装印刷电路板安装的可靠设计指南。
- IPC-2221关于印刷电路板设计的通用标准。
- IPC-2222关于刚性印刷电路板的组合设计标准。
- IPC-2223关于柔性印刷电路板的组合设计标准。
- IPC-2226关于高密度阵列或表贴架构外设的设计标准。
- 布板设计中,WL-CSP器件应该放置在机械应力和张力受力最均匀的位置,可能的话,可以在周围放置更高高度的器件作为支撑。
- 对于双层安装器件的PCB设计,应该在WL-CSP封装中心位置的对面安装封装尺寸更大器件。
- IPC-7351关于表贴设计的常规要求和安装模板的标准。
- 阻焊层限定(SMD)
- SMD焊盘在金属表面带有阻焊层开槽。
- 阻焊层开口小于金属焊盘。
- 阻焊层开槽材料一般为LPI (可成像液体感光胶),必须采用合适的材料以满足任何SMT处理工艺的要求。
- 非阻焊层限定(NSMD)
- NSMD焊盘(图5)为金属限定焊盘,焊盘周围有一个相应的阻焊层。
- 阻焊层开口大于金属焊盘。
- 阻焊层开槽材料一般为LPI (可成像液体感光胶),必须采用合适的材料以满足任何SMT处理工艺的要求。
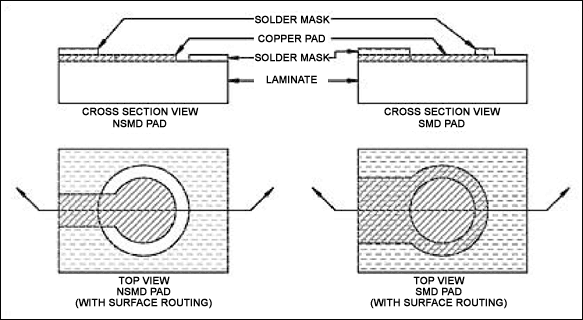
图4. WL-CSP的SMD与NSMD焊盘设计
图5. 非阻焊层限定(NSMD) PCB的刨面图
- 选择NSMD与SMD焊盘时必须考虑功率、接地和信号走向的要求。
- 考虑到元件焊球件的微小间隔,NSMD焊盘更容易布线。使用微过孔是简化布板的另一个途径。
- 特殊的微过孔设计可以避免表面空间,例如,采用“焊盘内过孔”设计。
- 空间允许的话,可以在焊盘相邻处放置一个过孔,可以方便布线,例如,“狗骨”式互连设计。
- 对于相同类型的封装,在一块PCB上不要混合使用不同类型的焊盘。
- 建议在所有焊盘之间使用阻焊层。
- 连接焊盘的引线宽度应该小于1/2的焊盘直径,WL-CSP球栅阵列的各侧布线应该保持对称。
金属表面涂层
- 有机可焊性保护层(OSP)
- 无电镀镍/浸金(ENIG)
- 浸锡电镀:不推荐使用热风整平(HASL)锡电镀。
- 高温FR4-FR5玻璃鳞片环氧树脂,对于无铅/符合RoHS标准的回流焊工艺,Tg (玻璃化温度) ≥ 170°C。
- 可选择BT压层材料。
- 酚醛玻璃鳞片环氧树脂材料:对于多次无铅回流安装,不推荐使用双氰胺(“dicy”) FR4材料。
- IPC-7525版膜设计指南。
过孔形状
- 为了改善焊膏从版膜的渗透,方形过孔优于圆形过孔。
- 采用梯形过孔,底层面积大于顶层面积。
- 过孔的四角可以采用弧形,以避免过孔中存在残留焊膏。
- 使用与焊球合金一致的焊膏或助焊剂材料。
- 使用低卤化物材料。
- 免洗松香助焊剂/松香可以省去手续的清洗流程。
- 使用3型或4型尺寸的焊膏。

焊接版膜的制作采用光刻不锈钢箔,采用电解法抛光或镍电镀(E-form)金属箔处理工艺。镍电镀成本较高,但容易在超小过孔处重复沉积焊膏,而且可以根据用户要求构成任意厚度的版膜。
自动放置元件
- 需要固定卷带送料器底座。
- 送料器底座松动会造成元件损失。
- 使用带照相定位的真空领纸装置或激光对准装置固定元件中心。
- 最好不要使用机械对准装置。
- 在PCB表面的安装高度必须精确,Z轴超程置为零或极小的负值。
- 同样适用于从卷带送料器拾取元件。
- 需要控制并监测所有WL-CSP硅片的垂直压力,建议在放置器件时选择机器作用力的下限,并适当降低放置探头的速度。
- 对于所有芯片级封装,建议测量放置元件时的垂直压力,将其作为机器设置流程的一个必要步骤。
- 用于放置元件的机器供应商可能提供特殊的低压力管口设置选项以及相应的端口,用于芯片级封装的安装。
- 放置元件时可能需要借助工具,以避免产生PCB位置偏移。
- 选择1:对于需要二次安装的设备,建议使用定制的PCB板装载器/托盘,这是一种最可靠的方式,可以避免元件互连以及后续的安装过程中产生PCB底层的位置偏移。
- 选择2:任何二次装配的拾取机器 *** 作时都可以利用支持PCB底层的可调节引脚,这对于高强度或高度密集的元件布板都是必要的。这些廉价工具通常在购买定位机时作为配件赠送,也可以从供应商处单独购买。
- 任何情况下,需要对芯片级封装采用人工 *** 作时,都要使用真空笔进行 *** 作。
- IPC J-STD-020非密封固态表贴器件的潮湿敏感度等级,1级潮湿敏感度。
- 所有Maxim WL-CSP器件符合工业标准的回流焊处理工艺。
- 可以选择氮惰性气体回流焊,但是,使用氮惰性气体时随着空气回流回增大无铅WL-CSP元件中心对PCB焊盘的受力(见图6和7)。
- 推荐使用强制气体对流回流炉。
- WL-CSP元件能够经受三次标准的回流焊。

图6. 易溶解的SnPb焊球WL-CSP的典型回流温度曲线。
图7. 无铅SAC焊球WL-CSP的典型回流温度曲线
注:1) 150s至210s浸锡区域限定在绿色曲线范围内;2) 温度高于220°C的时间限定在60s至90s区域;3) 温度高于235°C的时间在10s至30s;4) 峰值温度的时间限定在240s至360s。 请参考:J-STD-202 Rev D, 表4.1-4.2和5.2。
注:上述温度曲线仅供参考,实际回流温度应该按照回流炉规格、焊膏、元器件以及PCB安装工艺进行调整。
- 推荐使用2D X射线或3D X射线分层摄影法作为回流焊之后取样检查焊结短路、焊锡不足、漏焊及潜在的开路问题。
对于球栅阵列,建议采用聚焦红外技术,而不是传统的热气BGA返修系统。聚焦IR设备能够精确地定位引脚,消除回流焊锡,即使替换最小尺寸的CSP也不会由于受热造成与相邻元件的接触。
包装与运输为了防止损坏WL-CSP封装元件,包装与运输WL-CSP安装件或组件时必需小心。
Maxim WL-CSP可靠性数据 Maxim WL-CSP测试条件参考文献:
- JESD47集成电路应力测试规定。
表2. 晶片级测试
表3. 电路板级测试结果(WL-CSP元件安装在1.0mm厚的FR4–FR5板上)
Steady State JESD22-A101 (85°C, 85% RH, max operating voltage; three lots with 0/77 per lot)
Maxim的WL-CSP产品可靠性测试结果列在表4至表8。0.5mm焊球间隔、焊球阵列高达6 x 6的无铅WL-CSP产品均已通过认证测试。
Maxim无铅(SAC305) WL-CSP可靠性测试数据注:SAC305焊球(LF45)、Sn96.5/Ag3.0/Cu0.5金属合成物。
表4. 晶片级高温保存期限(HTSL)的测试数据(3个批次)
表5. 晶片级1级潮湿敏感度回流预处理测试数据(3个批次)
表6. 电路板级失效测试数据(累计失效)
表7. 电路板级加速温度周期变化(TC)的测试数据(3个批次)
表8. 电路板级高温工作期限(HTOL)的测试数据(每次3批)
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)