
传统的LED封装流程是将LED芯片(Chip)固定(Bonding)于散热基板之上,经由打线(Wire Bonding)或覆晶(Flip Chip)方式将线路连结,最后再以点胶、模具成型(Molding )等方式包覆LED芯片形成LED晶粒,最后将晶粒固定于电路载板(Circuit Board)之上,并整合电源(Power)、散热片(Heat Sink)、透镜(Lens)与反射杯( reflector)组成完整的照明模组。
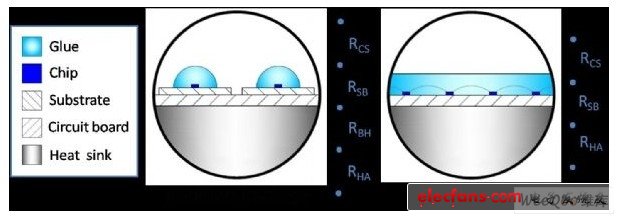
图1:LED封装示意图
表1:各式电路板比较
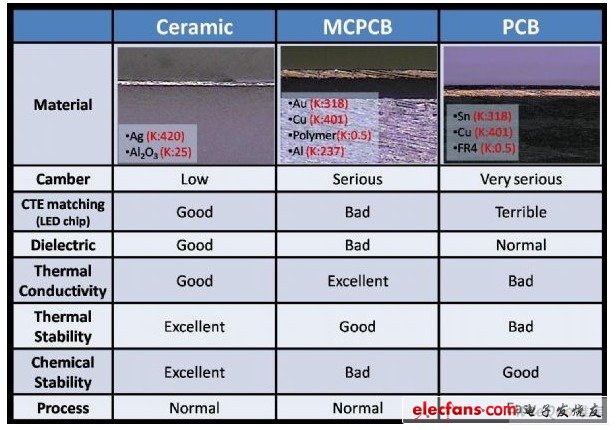
在照明模组中又以基板与电路载板所承受的热最为密集,因此直接与热源接触的基板都使用陶瓷作为材料,而当功率越来越高,元件越来越小的趋势下,陶瓷电路载板也逐渐被大量使用。 如表1所示,陶瓷电路载板比起传统电路板拥有更多适合LED照明的优势,可应用于高功率(HP)、高电压(HV)及交流电(AC)等LED照明,这些LED有较高的能量转换率或不用电源转换器的优势,所以整合两技术不但可提高LED照明稳定度之外,还能降低整体之总成本,使其更易导入家用照明市场。
但随着小体积要有更大照度的需求增加,单晶封装已不符合未来需求,所以COB(Chip On Board)LED封装技术随之而生,与传统芯片需固定于基板上再整合在电路载板的封装不同,如图1所示,COB封装是将单颗或多颗LED晶粒直接封装在电路载板上;另由热欧姆定理ΔT=QR得知,温差=热流x热阻,热阻愈大,就有愈大的热产生在元件内,因此COB封装方式可免除封装基板的使用,减少照明模组串连层数以强化LED散热效能。
此项技术可解决单颗高功率的封装所产生之高热,使其具有低热阻、低组装成本与单一封装体高流明输出等优势,现今已被大量用于照明灯具,但由于芯片所产生大量的热会直接与COB基板接触,因此当需要更高照度的照明模组时,旧有铝板(MCPCB)技术所制作之COB,会有热膨胀系数不匹配导致热倾斜的问题,因此陶瓷基板技术的引入有着势在必行的需求。
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)