
本文实现了一种正面开口的热电堆结构,采用XeF2作为工作气体干法刻蚀工艺释放器件。相对于刻蚀硅,XeF2气体对铝等材料的刻蚀速率极小,这样就可以采用标准CMOS工艺中最常用的材料,如Poly/Al 构成热电偶,从而大大提高兼容性。
1 设计和制作
本文提出的热电堆探测器包括硅基体、框架、热电堆、支撑臂、红外吸收层、刻蚀开口六部分,如图1 所示,其中,基体和悬浮于框架中间的红外吸收层分别构成热电堆的冷结区和热结区,支撑臂起到连接框架和红外吸收区以及承载热电堆的目的。支撑臂和红外吸收层是由在单晶硅上淀积的氧化硅和氮化硅复合膜构成。该结构的具体特征是制作了中间悬浮的红外吸收层,并设计了用于干法刻蚀基体的腐蚀开口。由于干法刻蚀的各向同性,腐蚀开口的形状可以多种多样,不同于湿法腐蚀开口必须严格沿着特定晶向排布,从而大大增加了设计的灵活性。

热电堆红外探测器是基于MEMS 技术加工的,工艺步骤如图2,图2 (a)复合介质膜的生长。在抛光的Si 片上,首先热生长氧化硅0.5~0.6μm,再用LPCVD 沉积SiN 0.1~0.2μm,形成氧化硅-氮化硅复合介质膜结构。(b)形成多晶硅条。在复合介质膜上用LPCVD沉积多晶硅(0.8~1.0μm),B离子注入掺杂,退火调整其方块电阻为30~40Ω。第一次光刻,BOE 腐蚀或离子束刻蚀形成多晶硅条,作为热偶的一种组分。(c)光刻引线孔。在(b)中形成的多晶硅上面,淀积一层氧化硅(0.5~0.6μm)作为绝缘层,第二次光刻,形成引线孔。(d)形成铝条和热电偶。溅射Al,第三次光刻,湿法腐蚀形成铝条,进而形成热电偶。(e)光刻刻蚀开口。第四次光刻,形成干法刻蚀的气体通道。(f)干法刻蚀释放结构。工作气体经由(e)中形成的刻蚀开口刻蚀硅衬底,形成悬浮的吸收层,释放热电堆结构。图3 是制作完成的热电堆器件。
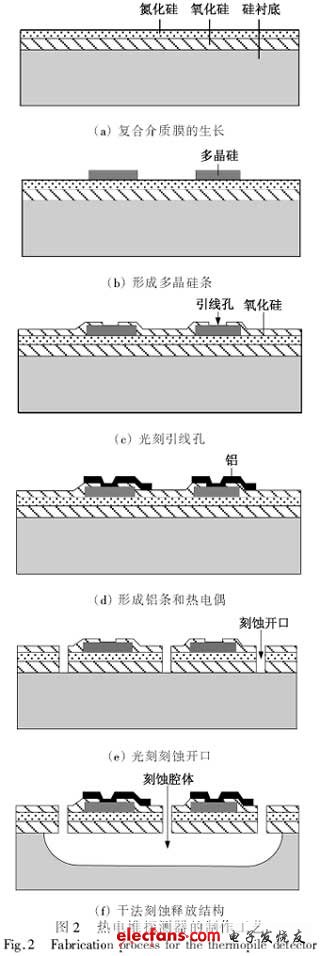
欢迎分享,转载请注明来源:内存溢出

 微信扫一扫
微信扫一扫
 支付宝扫一扫
支付宝扫一扫
评论列表(0条)